顕微鏡ソリューション
半導体製造工程
- ホーム
- 顕微鏡ソリューション 半導体製造工程
- フォトリソグラフィ
フォトリソグラフィ
フォトリソグラフィーは、ウェハ上に集積回路パターンを形成するプロセスです。
このプロセスを数回繰り返し、複雑な回路パターンを作ります。
オリンパスOLS5000は、フォトレジストとパターンの厚さを測定できます。
フォトレジスト工程におけるレジスト高さ
フォトリソグラフィー工程でシリコンウェハ上に設計されたパターンを形成します。 ウェハ上のパターンを正しく形成するには、レジストの厚さを管理する必要があります。
私たちのソリューション
最表面検出フィルターを使用すると、OLS5000はシリコンウェハからの散乱光の影響を取り除き、レジスト最表面だけを正しく取得できます。 また、スキップスキャンモードで、高速でデータを取得することができます。
3D測定レーザー顕微鏡 OLS 5000 | フォトレジスト 使用対物レンズ:MPLAPON100xLEXT | 散乱光 散乱光の影響を取り除く |
アプリケーションノート
関連アプリケーションの詳細情報をご参照ください。
| |||
|
フォトレジスト残渣のチェック
フォトレジストは、その残留物が電気回路の誤動作の原因となるため、リソグラフィプロセスの最後にウェーハから完全に除去する必要があります。 しかし非常に小さいため、フォトレジストの残渣を見つけるのは難しいです。
私たちのソリューション
蛍光観察ユニットを備えたMXシリーズによって、レジスト残渣は明るく発光させられるので、検出が容易になります。自動ウェハ搬送機ALと組み合わせる事で信頼性の高いウェハ検査がスピーディーに行う事ができます。
半導体検査顕微鏡 |  レジスト残渣の蛍光観察 |
アプリケーションノート
関連アプリケーションの詳細情報をご参照ください。
| |||
|
エッチング後のIC回路のチェック
エッチング後にパターンの寸法をチェックします。 パワー半導体の基板として使用されている SiCウエハ上のパターン(トレンチ)も測定する必要があります。
私たちのソリューション
パターンサイズが小さくなり、測定値の正確さが要求されます。 SiC上のトレンチのサイズは約1umです。 OLSは、エッチング後のパターンの測定に有効です。
3D測定レーザー顕微鏡 | 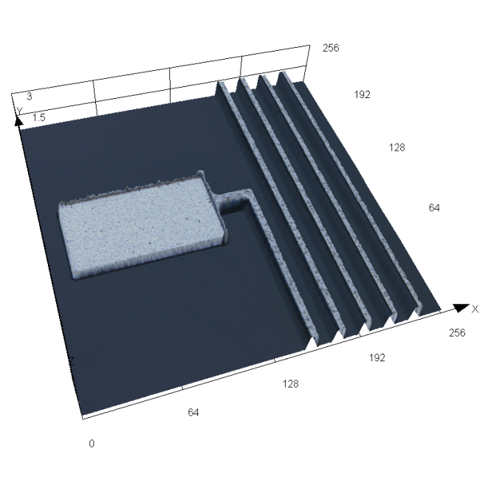 Siウェハ上の回路 | SiC ウェハの断面 |
アプリケーションノート
関連アプリケーションの詳細情報をご参照ください。
| |||
| |||
|
回路の欠陥検出
製造装置の劣化、調整不足、人為的ミス、汚染などにより、ウェハに欠陥が発生する場合があります。 これらの欠陥を検出することが重要です。
私たちのソリューション
欠陥検査に使用するMXシリーズ、DSX1000。オペレータは、欠陥検出に最適な観察方法を用いて広視野の低倍率で欠陥を検出します。 そして、欠陥の詳細を高倍率で解析します。
DSXシリーズは大型ステージのカスタマイズも可能です。また観察方法の切替えも簡単で、欠陥検出~詳細解析まで簡便でスピーディーに行うことができます。
半導体検査顕微鏡 | デジタルマイクロスコープ | 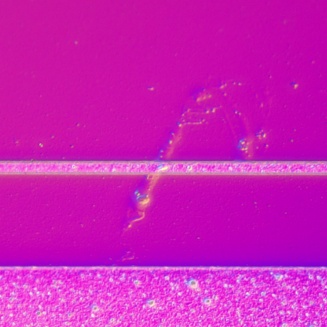 高倍率での微分干渉観察 |
アプリケーションノート
関連アプリケーションの詳細情報をご参照ください。
| |||
 |
|
半導体検査顕微鏡 MX 見積もりのお申込み | デジタルマイクロスコープ DSX1000 見積もりのお申込み |