リソースに戻る
フォトレジストの膜厚測定

シリコンウエハー
アプリケーション
半導体製造ではフォトリソグラフィーによってシリコンウェーハ上に設計パターンを印刷する必要があります。
ウェハー上のパターンを正しく設計するためには、レジストの厚さを管理する必要があります。
しかし、レジスト下のシリコンからの反射光によって、レジストの膜厚が正しく測定できない場合があります。
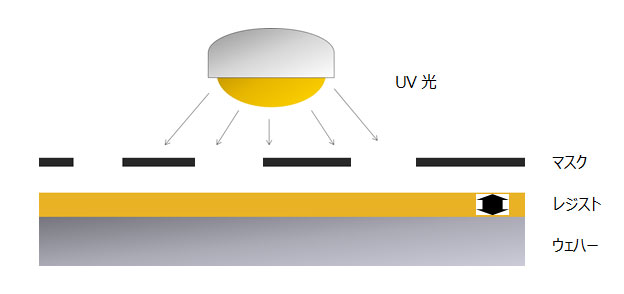
オリンパスのソリューション
オリンパス3D測定レーザー顕微鏡LEXTによる測定
商品の特徴
① 最表面検出フィルターを使用することにより、透明なレジスト幕であっても、下のウェハーからの散乱光を除去して、レジストの膜厚を正確に測定することができます。
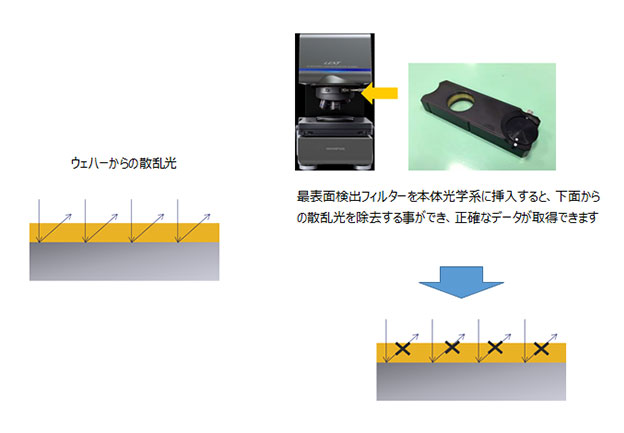
② データ取得に必要な範囲のみをスキャンするスキップスキャン機能により、データの取得速度が格段に速くなりました。例えば、23umの厚さのレジストのデータを取得時間がわずか10秒であったという事例があります。

この用途に使用される製品

LEXT OLS5100は、非接触・非破壊で微細な3D形状の観察・測定が可能なレーザー顕微鏡です。 サブミクロンオーダーの微細な形状測定に優れ、スタートボタンを押すだけでオペレーターの習熟度に左右されない測定結果を得ることができます。 また、新開発の『実験トータルアシスト』により、実験計画作成からデータ取得・解析、分析・データ出力までを一括管理することで、人為的なミスを低減し、手戻りを防ぎます。ISO/IEC 17025認定校正に対応しています。
このページはお住まいの地域ではご覧いただくことはできません。
このページはお住まいの地域ではご覧いただくことはできません。
Let us know what you're looking for by filling out the form below.
Redirecting
You are being redirected to our local site.
このページはお住まいの地域ではご覧いただくことはできません。