Микроскопы для применения
в сфере производства полупроводников
Фотолитография
Фотолитография — это процесс нанесения рельефа интегральной схемы на полупроводниковую пластину. Этот процесс повторяется несколько раз для создания сложных рельефов.
Измерение толщины фоторезиста в процессе нанесения слоя фоторезиста
Требуемый рельеф схемы наносится на кремниевую полупроводниковую пластину методом фотолитографии. Для правильного нанесения рельефа на пластину критическое значение имеет толщина слоя фоторезиста.
Наше решение
Благодаря фильтрам QWP лазерный конфокальный микроскоп OLS5000 устраняет эффект рассеянного света с поверхности кремниевой пластины и захватывает четкое изображение профиля поверхности. Режим пропуска этапа сканирования позволяет ускорить процесс получения изображений.
Лазерный сканирующий микроскоп серии OLS | Изображение слоя фоторезиста, полученное с использованием объектива MPLAPON100xLEXT | Рассеянный свет Устраняет эффект рассеянного света |
Указания по применению
Подробнее об областях применения:
| |||
|
Контроль остаточного фоторезиста
По завершении процесса литографии фоторезист необходимо полностью удалить с полупроводниковой пластины, поскольку его остатки вызывают сбои в работе электрического контура. Контроль остатков фоторезиста это сложный процесс ввиду малого размера частиц.
Наше решение
В режиме наблюдения с флуоресцентным освещением на промышленных микроскопах серии MX остатки фоторезиста подсвечиваются для облегчения процесса контроля. Для большей оптимизации рабочего процесса микроскоп можно использовать с дополнительным автоматическим загрузчиком пластин.
Микроскоп серии MX для анализа полупроводников |  Наблюдение остатков фоторезиста с флуоресцентным освещением |
Указания по применению
Подробнее об областях применения:
| |||
|
Контроль рельефа ИС на полупроводниковой пластине после этапа травления
Карбидокремниевые (SiC) полупроводниковые пластины используются в качестве подложки для силовых полупроводников. После травления выполняется контроль размеров рельефа на полупроводниковой пластине. Современные полупроводники имеют малый размер, в связи с чем для их анализа требуется высокоточное оборудование. В рамках контроля качества необходимо измерять рельеф (бороздки) на SiC полупроводниковой пластине. Размер бороздок на пластине составляет около 1 мкм.
Наше решение
Наш микроскоп серии OLS способен измерять мельчайшие детали рельефа, нанесенного в процессе травления.
Лазерный сканирующий микроскоп серии OLS | 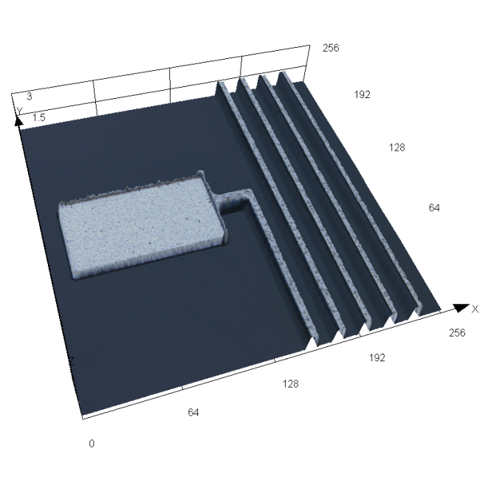 Рельеф на SiC полупроводниковой пластине | Поперечный срез SiC полупроводниковой пластины |
Указания по применению
Подробнее об областях применения:
| |||
| |||
|
Обнаружение дефектов рельефа
В связи с износом производственного оборудования, неправильными настройками, ошибками, вызванными человеческим фактором, и загрязнениями на полупроводниковых пластинах могут появляться дефекты, которые важно своевременно выявлять.
Наше решение
Наши микроскопы серий MX и DSX являются подходящими инструментами для контроля дефектов. Оператор выбирает оптимальный режим наблюдения для обнаружения дефектов при малом увеличении, а затем определяет тип дефекта при большом увеличении. Микроскоп серии DSX (со специализированным большим предметным столиком) значительно упрощает рабочий процесс за счет возможности быстрой смены режима наблюдения.
Микроскоп серии MX для анализа полупроводников | Цифровой микроскоп серии DSX | 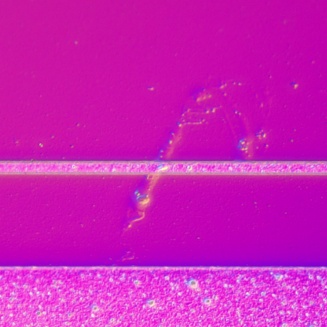 Наблюдение в режиме ДИК при большом увеличении |
Указания по применению
Подробнее об областях применения:
| |||
 |
|
Микроскоп серии MX для анализа полупроводников Запросить цену | Цифровой микроскоп серии DSX Запросить цену |