Mikroskoplösungen für
die Herstellung von Halbleitern
Fotolithografie
Die Fotolithografie ist der Prozess, mit dem Strukturen für integrierte Schaltkreise auf den Wafer aufgebracht werden. Dieser Vorgang wird mehrmals wiederholt, um komplexe Schaltungsstrukturen zu erzeugen.
Messung der Lackdicke im Fotolack-Prozess
Der Prüfer druckt die entworfene Struktur mittels Fotolithografie auf den Siliziumwafer. Die Beherrschung der Fotolackdicke entscheidet dafür, ob die Struktur korrekt auf den Wafer gedruckt wird.
Unsere Lösung
Mit QWP-Filtern kann unser konfokales OLS5000 Lasermikroskop den Streulichteffekt vom Silizium unterdrücken und das Oberflächenprofil genau erfassen. Der Skip-Scan-Modus erleichtert zudem die schnelle Erfassung.
Laser-Scanning-Mikroskop der OLS-Serie | Fotolack, aufgenommen mit einem Objektiv MPLAPON100xLEXT | Streulicht Unterdrückung von Streulicht |
Anwendungsbeispiele
Weitere verwandte Anwendungen:
| |||
|
Prüfung auf Fotolack-Rückstände
Der Fotolack muss am Ende des Lithografieprozesses vollständig von den Wafern entfernt werden, da seine Rückstände zu Fehlfunktionen der elektrischen Schaltungen führen. Rückstände von Fotolacken sind aufgrund ihrer geringen Größe schwer zu erkennen.
Unsere Lösung
Die Fluoreszenzmikroskopie mit unserem Industriemikroskop der MX-Serie hellt die Rückstände zur leichteren Erkennung auf. Die Kombination des Mikroskops mit dem optionalen Auto-Wafer-Loader ermöglicht hocheffiziente Inspektionen.
Mikroskop der MX-Serie für die Halbleiterindustrie |  Fluoreszenzmikroskopie zur Erkennung von Fotolack-Rückständen |
Anwendungsbeispiele
Weitere verwandte Anwendungen:
| |||
|
Prüfung von IC-Strukturen auf einem Wafer nach dem Ätzen
Als Substrat für einen Leistungshalbleiter wird ein Siliziumkarbid(SiC)-Wafer verwendet. Ein Prüfer prüft die Strukturabmessungen auf dem Wafer nach dem Ätzen. Da die Strukturgrößen immer kleiner werden, ist eine höhere Genauigkeit bei der Überprüfung erforderlich. Die Struktur (Trench) auf dem SiC-Wafer muss ebenfalls vermessen werden. Die Trenchgröße auf dem SiC-Wafer beträgt etwa 1 μm.
Unsere Lösung
Unsere Mikroskope der OLS-Serie können diese feinen Strukturen nach dem Ätzen messen.
Laser-Scanning-Mikroskop der OLS-Serie | 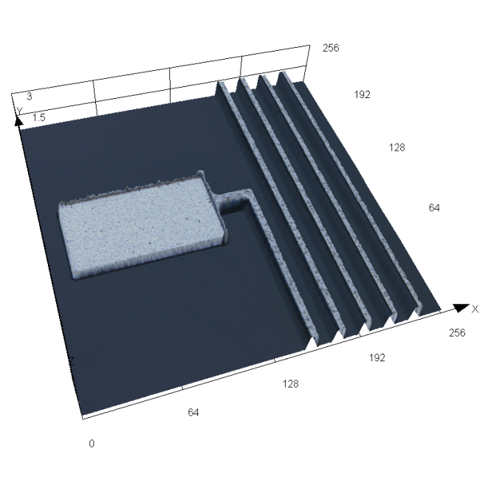 Strukturen auf SiC-Wafer | Querschnitt durch einen SiC-Wafer |
Anwendungsbeispiele
Weitere verwandte Anwendungen:
| |||
| |||
|
Erkennung von Strukturdefekten
An Wafern können Defekte durch Verschleiß der Fertigungsanlagen, unzureichende Justierung, menschliches Versagen und Verunreinigungen auftreten, die unbedingt erkannt werden müssen.
Unsere Lösung
Unsere Mikroskope der MX- und DSX-Serie können zur Prüfung von Fehlern eingesetzt werden. Der Bediener wählt eine geeignete Beobachtungsmethode, um Defekte mit geringer Vergrößerung zu erkennen und bestätigt dann die Art des Defekts mit hoher Vergrößerung. Unsere DSX-Serie (mit einem kundenspezifischen, großen Tisch) ermöglicht einen einfachen Arbeitsablauf und eine leichte Änderung der Beobachtungsmethoden.
Mikroskop der MX-Serie für die Halbleiterindustrie | Digitalmikroskop der DSX-Serie | 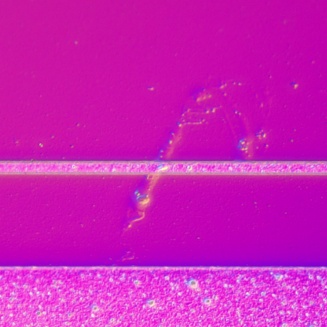 DIC-Beobachtung mit hoher Vergrößerung |
Anwendungsbeispiele
Weitere verwandte Anwendungen:
| |||
 |
|
Mikroskop der MX-Serie für die Halbleiterindustrie Angebot anfordern | Digitalmikroskop der DSX-Serie Angebot anfordern |