顕微鏡ソリューション
半導体製造工程
- ホーム
- 顕微鏡ソリューション 半導体製造工程
- ダイボンディング
ダイボンディング
ICチップをリードフレームの指定された場所にマウントします。
オリンパスBXとMXは、ダイボンディング後の検出の検査と分析をサポートします。
ダイボンディング後の欠陥検査
ダイボンダの一部がICチップの表面に当たり、キズがつく場合があります。 その対策を講じるために、詳細解析でキズの原因を特定する必要があります。
私たちのソリューション
BX、MXシリーズを使用すると、オペレーターはICチップの欠陥を高倍率で観察できます。
工業顕微鏡 | 半導体検査顕微鏡 | 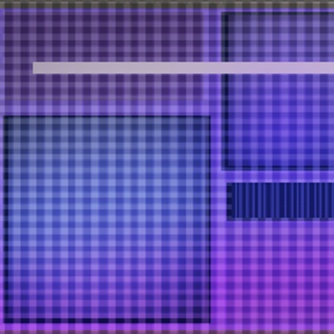 ダイボンディング後のICチップ |
アプリケーションノート
関連アプリケーションの詳細情報をご参照ください。
| |||
|
工業顕微鏡 BX 見積もりのお申込み | 半導体検査顕微鏡 MX 見積もりのお申込み |
Not available in your country.
Not available in your country.
