I microscopi d'ispezione Evident assicurano flessibilità permettendo agli utenti di visualizzare i campioni attraverso diversi metodi di osservazione. Questi includono il metodo di osservazione MIX, un metodo di illuminazione che può combinare il campo scuro con un altro metodo di osservazione, come il campo chiaro, la polarizzazione semplice o la fluorescenza, per mostrare contemporaneamente più dettagli del proprio campione. L'osservazione MIX è anche conosciuta come illuminazione MIX o tecnologia MIX.

Figura 1. Diagramma schematico dell'osservazione MIX.
Inserita nel revolver di un microscopio per ispezione, la nostra slitta MIX U-MIXR-2 rende applicabile questo metodo di osservazione. Continua a leggere per scoprire di più sull'osservazione MIX e su come facilita l'ispezione per la ricerca di difetti in wafer.


Figura 2. Parte frontale e posteriore della slitta MIX U-MIXR-2.

Figura 3. Un microscopio compatto installato in un dispositivo con un illuminatore U-KMAS dotato della slitta MIX.
Ispezione per la ricerca di difetti in wafer semiconduttore mediante il campo chiaro e campo scuro
La combinazione del campo chiaro e campo scuro attraverso l'osservazione MIX è particolarmente utile per l'ispezione per la ricerca di difetti in wafer. Il campo chiaro evidenzia i dettagli superficiali come il colore, mentre il campo scuro evidenzia i dettagli dei pattern come piccoli graffi e difetti. Combinandoli in un unico metodo gli utenti possono osservare contemporaneamente pattern e colori di un wafer.

Figura 4. Combinando l'osservazione del campo chiaro e campo scuro è possibile vedere contemporaneamente il colore e il pattern del circuito integrato (IC) del wafer, permettendo di rilevare velocemente problematiche potenziali e risparmiare tempo durante l'ispezione.
Identificazione di posizioni di wafer mediante la fluorescenza e il campo scuro
Un'altra utile modalità di utilizzo dell'osservazione MIX è quella di combinare la fluorescenza e il campo scuro. Nelle ispezioni di semiconduttori, l'illuminazione a fluorescenza è in genere usata per ispezionare particelle residue di fotoresist. Tuttavia risulta spesso difficile determinare la posizione dell'oggetto quando si utilizza questo metodo di illuminazione. La buona notizie è che la posizione dell'oggetto può essere determinata mediante il campo scuro. Nell'ispezione di wafer, combinando la fluorescenza e il campo scuro attraverso l'osservazione MIX è possibile determinare la posizione di un wafer, osservare la forma del pattern e vedere il resist indesiderato.
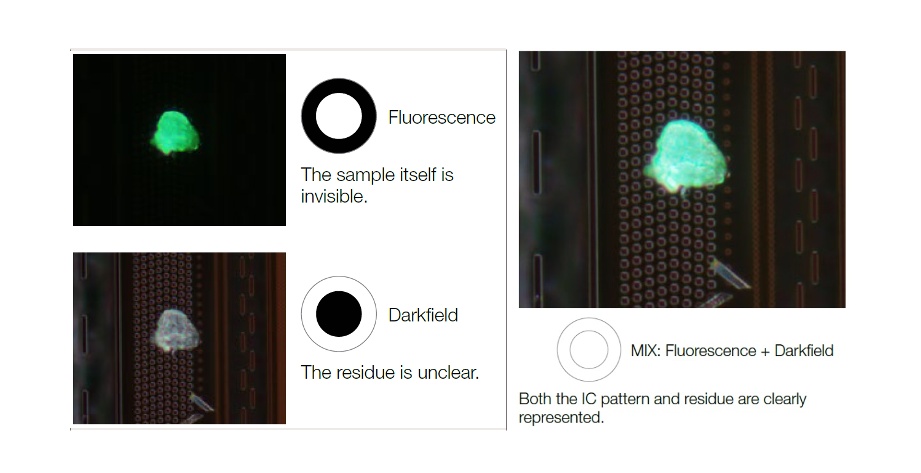
Figura 5. Combinando la fluorescenza e il campo scuro migliora l'ispezione del pattern e del residuo IC.
Illuminazione flessibile utilizzando il campo scuro direzionale
Un importante vantaggio dell'illuminazione MIX è rappresentato dalla funzionalità di campo scuro direzionale, il quale permette di controllare la quantità e la direzione di luce nel campione. I 16 LED possono essere controllati separatamente per illuminare un oggetto e un angolo obliquo da qualsiasi direzione. Questa funzionalità permette di distinguere superfici che si elevano da avvallamenti, oltre a evidenziare nuove peculiarità e difetti. È inoltre possibile combinare il campo scuro direzionale con il campo chiaro, la polarizzazione e la luce trasmessa o la fluorescenza per evidenziare ulteriormente i dettagli.
Controlla le seguenti immagini esemplificative del campo scuro direzionale:
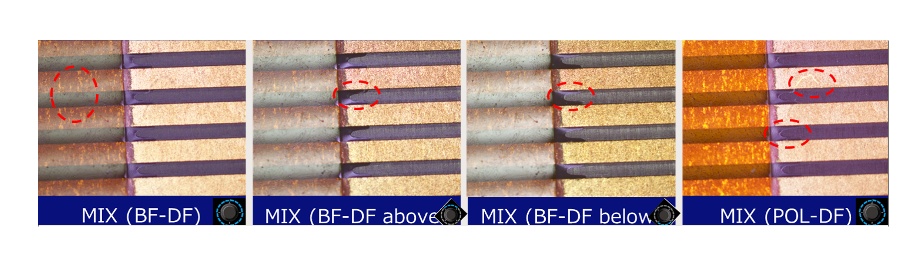
Figura 6. Dettagli superficiali evidenziati in un cavo a nastro combinando il campo scuro direzionale con un altro metodo di osservazione utilizzando l'osservazione MIX. Il blu nella selezione mostra la direzione della luce dal campo scuro direzionale, mentre il cerchio rosso indica l'area sotto osservazione.
Immagini della Figura 6 da sinistra a destra:
- Osservazione MXI mediante il campo chiaro e il campo scuro permette di osservare contemporaneamente la superficie di rivestimento in poliammide e il foglio in rame
- L'osservazione MIX del campo chiaro e campo scuro angolati soprastanti permette di osservare contemporaneamente la parte piana e la forma inclinata sottostanti
- L'osservazione MIX del campo chiaro e campo scuro angolati sottostanti permette di osservare la parte piana e la forma inclinata soprastanti
- L'osservazione MIX della polarizzazione e del campo scuro permette di osservare contemporaneamente la contaminazione e la forma concava
Combinazione dell'osservazione MIX nella struttura dello strumento
L'osservazione MIX può permettere di risparmiare tempo durante le ispezioni mostrando contemporaneamente maggiori dettagli. In questo modo rappresenta un utile strumento per le applicazioni che adottano una combinazione di campo scuro e di altri metodi di osservazione.
- Microscopio metallurgico verticale BX53M
- Microscopio metallurgico inverso GX53
- Microscopio per l'ispezione di wafer MX63 / MX63L
- Microscopio di misurazione STM7
- Microscopi modulari BXFM
Inoltre alcune versioni precedenti dei nostri microscopi della serie BX™ o MX™ possono essere aggiornate all'osservazione MIX mediante componenti addizionali.
Per maggior informazioni sulle nostre componenti ottiche di alta qualità che possono essere integrate nel nostro dispositivo di imaging, visitare il nostro Centro Risorse OEM . È inoltre possibili visitare la nostra pagina sui microscopi industriali per ottenere maggior informazioni sui microscopi che utilizzano l'illuminazione MIX.
Contenuti correlati
Individuare i difetti di produzione sui wafer semiconduttori utilizzando un microscopio digitale