Os microscópios de inspeção Evident proporcionam flexibilidade ao permitir que os usuários visualizem as amostras usando diversos métodos de observação. Entre eles, temos o método MIX, um método de iluminação capaz de combinar campo escuro com outro método de observação, p. ex., campo claro, polarização simples ou fluorescência, mostrando imediatamente mais detalhes em sua amostra. A observação MIX também é conhecida por iluminação MIX ou tecnologia MIX.

Figura 1. Diagrama esquemático da observação MIX.
Esse método de observação é viabiliza por nosso deslizador MIX U-MIXR-2 acoplado ao revólver porta-objetivas giratório de um microscópio de inspeção. Continue lendo e saiba mais sobre a observação MIX e como ela auxilia na inspeção de defeitos em wafers.


Figura 2. Apresentações anterior e posterior do deslizador MIX U-MIXR-2.

Figura 3. Microscópio compacto instalado em um dispositivo com iluminador U-KMAS e equipado com o deslizador MIX.
Inspeção de defeito em wafer semicondutor usando campo claro e campo escuro
A combinação de campo claro e campo escuro por meio da observação MIX é particularmente útil para a inspeção de defeito em wafers. O campo claro melhora os detalhes superficiais, como a cor, enquanto o campo escuro melhora os detalhes nas bordas, como defeitos e arranhões ocasionais. Ao combiná-los em um só método, outros usuários podem ver imediatamente os padrões e as cores de um wafer.

Figura 4. Combinação das observações de campo claro e campo escuro mostrando imediatamente os padrões de cor e circuito integrado (CI) do wafer, permitindo a detecção de possíveis problemas com rapidez e poupando tempo durante a inspeção.
Identificação da localização de um wafer usando fluorescência e campo escuro
A combinação de fluorescência e campo escuro é mais uma maneira útil para o uso da observação MIX. Normalmente, a iluminação de fluorescência é usada para inspecionar resíduos de partículas fotorressistentes em inspeções de semicondutores. No entanto, a determinação da posição do objeto usando costuma ser difícil com esse método de iluminação. A boa notícia é que é possível encontrar a posição do objeto usando a técnica de campo escuro. Na inspeção de wafers, a combinação de fluorescência e campo escuro por meio da observação MIX torna possível determinar a posição de um wafer, observar seu formato de estampagem e visualizar resistência indesejável.
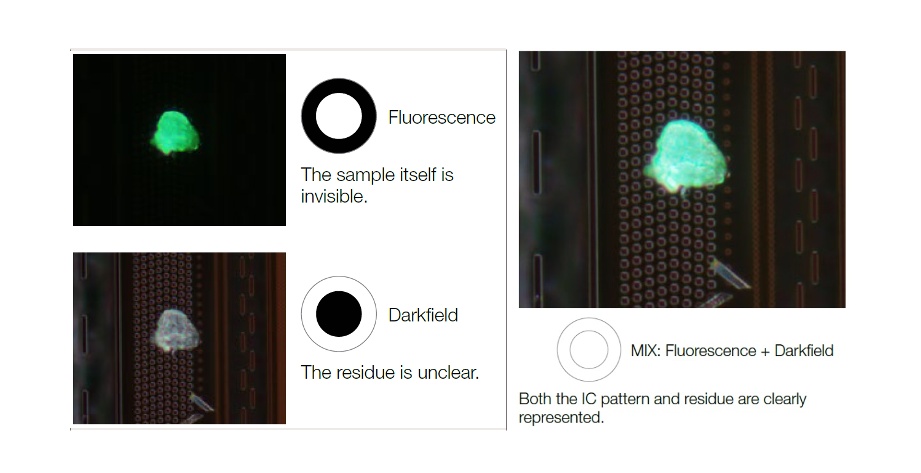
Figura 5. A combinação de observação por fluorescência e campo escuro melhora a inspeção de resíduos e do padrão de CI.
Iluminação flexível usando campo escuro direcional
Uma vantagem importante da iluminação MIX é o recurso de campo escuro direcional, que proporciona o controle da quantidade e da direção da luz na amostra. É possível controlar os 16 LEDs separadamente a fim de iluminar um objeto com um ângulo oblíquo de qualquer direção. Essa capacidade permite que você diferencie superfícies elevadas ou em depressão, assim como destacar novas características e defeitos. Também é possível combinar campo escuro direcional com campo claro, polarização, luz transmitida ou fluorescência para melhorar ainda mais os detalhes.
Confira as imagens abaixo para obter exemplos de campo escuro direcional:
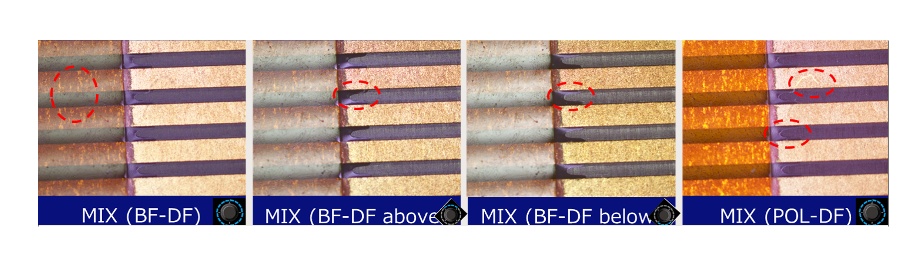
Figura 6. Detalhes superficiais aprimorados em um cabo composto mediante a combinação de campo escuro direcional com outro método de observação usando a observação MIX. A cor azul no indicador mostra a direção da luz proveniente do campo escuro direcional, enquanto o círculo vermelho indica a área observada.
Imagens da Figura 6 (da esquerda para a direita):
- Observação MIX usando campo claro e campo escuro, permitindo observar a superfície do revestimento de poliimida e a folha de cobre ao mesmo tempo
- Observação MIX de campo claro e campo escuro com angulação superior, permitindo observar a parte plana e o formato inclinado abaixo ao mesmo tempo
- Observação MIX de campo claro e campo escuro com angulação inferior, permitindo observar a parte plana e o formato inclinado acima
- Observação MIX de polarização e campo escuro, permitindo observar a contaminação e o formato côncavo ao mesmo tempo
Combinação da observação MIX ao projeto de instrumentos
Ao mostrar imediatamente mais da sua amostra, a observação MIX pode poupar tempo durante inspeções, sendo uma ferramenta útil para aplicações que usam uma combinação de campo escuro e outros métodos de observação.
- Microscópio metalúrgico vertical BX53M
- Microscópio metalúrgico invertido GX53
- Microscópio de inspeção de wafers MX63/MX63L
- Microscópio de medição STM7
- Microscópios modulares BXFM
Além disso, é possível implementar a observação MIX atualizando algumas versões anteriores de nossos microscópios séries BX™ e MX™ com a instalação de componentes adicionais.
Para saber mais sobre nossos componentes ópticos de alta qualidade que podem ser incorporados ao seu dispositivo de formação de imagem, acesse nossa central de recursos para fabricante do equipamento original. Acesse também nossa página sobre microscópios industriais para conhecer os microscópios que utilizam iluminação MIX.
Conteúdo relacionado
Detecção de defeitos de fabricação em wafers semicondutores com microscópios digitais
Uma maneira inteligente de controlar a contaminação para metrologia e inspeção de alto rendimento