OLS4500
Produits non poursuivis
Vue d’ensemble
Le LEXT OLS4500 est un microscope de recherche fonctionnant à l'échelle nanométrique. Il associe un microscope laser et un microscope à sonde à balayage pour pouvoir observer et mesurer avec un large éventail de grossissements (d'environ 50x à 1 000 000 x)
- De nouvelles solutions désormais possibles avec le microscope OLS4500
- Observation et mesure intégrées possibles avec le microscope OLS4500
- Six modes de mesure SPM avec des instructions faciles à suivre qui s'affichent à l'écran
- Un LSM permet une manipulation flexible de plusieurs échantillons
- Mesure sans contact de la rugosité de surface de micro zones
- Technologies de microscopie du OLS4500
De nouvelles solutions désormais possibles avec le OLS4500
Ne perd jamais la cible une fois qu'elle est capturée.
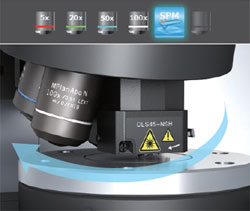 Passage de la méthode de grossissement à la méthode d'observation et vice versa grâce à la tourelle porte-objectifs rotative | Quatre objectifs allant d'un faible grossissement à un grossissement élevé sont installés sur la tourelle porte-objectifs rotative motorisée avec une unité SPM.Le basculement entre la méthode de grossissement à la méthode d'observation et vice versa se fait facilement de sorte que la cible observée reste dans le champ de vision. Le microscope OLS4500 effectue rapidement des recherches sur des textures de surface nanométriques. |
Un large éventail de grossissements et diverses méthodes d’observation permettent de détecter facilement la cible observée.
Avec son large éventail de grossissements et ses diverses méthodes d’observation, associés à une technologie optique avancée, le microscope optique peut facilement localiser la cible observée. De plus, avec l'observation laser DIC (Differential Interference Contrast), il est possible de visualiser en temps réel des irrégularités de l'ordre du nanomètre dans une image.
 Observation sur fond clair (motif IC) |  Observation DIC |  Observation laser DIC |
Réduit le temps de travail entre le placement de l'échantillon et l'acquisition d’images.
Une fois que l'échantillon a été placé sur le microscope OLS4500, toutes les opérations ultérieures peuvent être réalisées sur le même microscope. La faculté de localiser rapidement et avec précision la cible observée avec le SPM se traduite par l’acquisition des images cibles dans une seule zone de balayage.
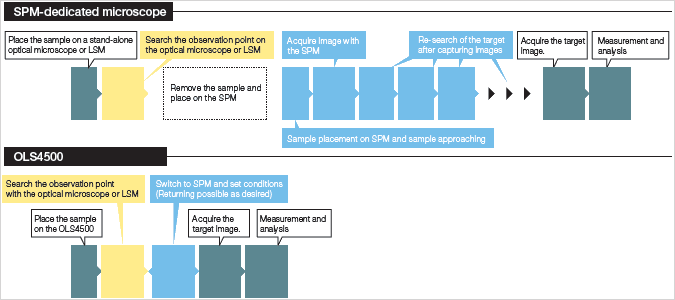
Une conception intégrée sur un seul microscope. En basculant du mode grossissement au mode observation, plus besoin d’enlever et de repositionner l'échantillon sur un autre microscope.
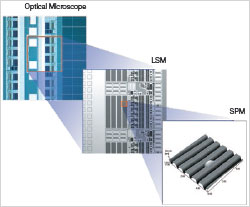 | Le OLS4500 étant un système microscope optique laser doté d'une sonde intégrée, vous pouvez basculer entre les trois modes pour l'observation et l'évaluation sans devoir replacer l'échantillon. Chacun des microscopes intégrés est équipé d'un éventail de fonctions puissantes pour garantir un résultat optimal. |
Des observations et des mesures faciles grâce au microscope OLS4500
【Trouver】Trouve immédiatement la zone d’intérêt
Le microscope OLS4500 peut localiser rapidement la zone d’intérêt grâce à ses diverses méthodes d'observation et de grossissement, en gardant l'objet dans le champ de vision.
Méthodes.
Une LED blanche est utilisée comme source lumineuse pour garantir des images en couleurs nettes et un excellent rendu des couleurs. Les quatre objectifs permettent différents grossissements, de faibles à élevés. Grâce à toutes ses fonctionnalités, le microscope optique OLS4500 est capable de réaliser des observations en fond clair (FC) - l'observation DIC (Differential Interference Contrast) la plus couramment utilisée pour la visualisation stéréoscopique de textures de surface fines en améliorant le contraste, mais aussi pour l'observation simplifiée par lumière polarisée (caractéristiques de polarisation de l'échantillon avec des couleurs différentes). Parmi ses autres fonctionnalités figure la HDR (plage dynamique étendue) qui synthétise plusieurs images capturées en faisant varier le temps d'exposition afin d'obtenir une luminosité équilibrée et une meilleure texture de l’image. Le microscope OLS4500 peut trouver rapidement la zone d’intérêt en utilisant différentes méthodes d’observation.
Un LSM peut visualiser ce qui ne peut pas être observé avec un microscope optique.
Grâce à une lumière laser d’une longueur d’onde de 405 nm, des lentilles d'objectif à grande ouverture, des systèmes optiques confocaux et une résolution X - Y élevée, les objets non visibles peuvent être observés avec le microscope optique sur des images claires. Avec l'observation laser DIC, rend possible les nano-surfaces peuvent désormais être observées.
 Observation sur fond clair (matériaux étrangers sur plaque en verre) |  Observation laser DIC |
【Approche】Approche rapide et précise de la zone d’intérêt avec un SPM
Observation avec un grossissement progressif qui maintient l'objet dans un champ de vision
Quatre objectifs, allant d'un faible grossissement à un grossissement élevé, sont installés sur la tourelle porte-objectifs rotative motorisée avec l'unité SPM. Les modes d'observation en temps réel 50X et 100X avec le microscope optique ou le LSM placent la zone de balayage SPM au centre du champ. Il est possible de s'approcher précisément de la zone d’intérêt en paramétrant une marque cible sur la zone et en passant au mode de balayage de la sonde. L'image cible peut donc être obtenue avec un seul balayage SPM, ce qui améliore la productivité et réduit l'usure du cantilever.
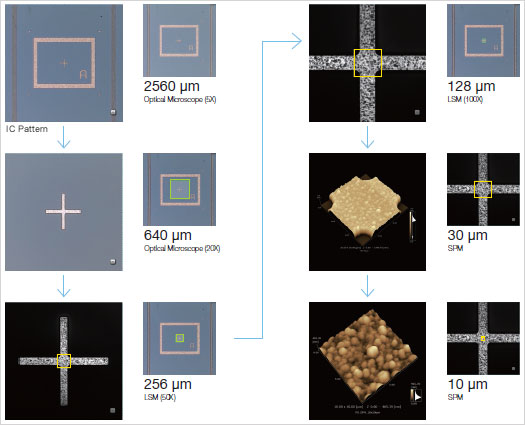
Consignes pour faciliter le basculement en observation SPM |
 | Tous les opérateurs, même les novices, peuvent effectuer les tâches pré-observation SPM (installation du cantilever et réglage de la zone de balayage) en suivant les consignes affichées. |
【Mesure avec une approche nanométrique】Mesure rapide avec des opérations simples
Nouvelle tête d'inspection SPM avec réduction du bruit
 Nouvelle tête d’inspection de scanner SPM compacte | Le OLS4500 utilise une tête de scanner SPM montée sur une tourelle porte-objectifs. Puisque l'objectif et la pointe du cantilever sont en position coaxiale parfocale, le point d'observation ne sort pas du champ de vision même après avoir basculé en mode SPM. La nouvelle tête SPM compacte présente une meilleure rigidité ainsi qu’une réduction du bruit de l'image et une amélioration de la réactivité. |
Navigateur pour agrandir la région tel que requis
La fonction de navigateur permet un visionnement plus proche de la région souhaitée dans une image acquise avec le mode de balayage de la sonde et en augmentant davantage le grossissement. L'image cible peut être obtenue en réglant simplement la région d'agrandissement à l'aide du curseur et en commençant le balayage de la sonde. La zone de balayage peut être paramétrée librement pour simplifier l'observation et les mesures.

Le navigateur agrandit une zone de 3,5 μm x 3,5 μm en une image de 10 μm x 10 μm
Analyses permettant de répondre aux différentes exigences
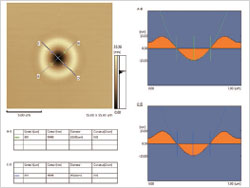 Mesure de courbure (trous de disque dur) | Les images acquises en mode de mesure SPM peuvent être analysées selon les exigences de différentes applications, et les résultats peuvent être exportés au format CSV. Le microscope OLS4500 est doté des fonctions d’analyse suivantes.
|
Six modes de mesure SPM avec affichage des consignes faciles à suivre
Mode contact
Ce mode balaie statiquement la zone de paramétrage par le cantilever tout en maintenant la force de répulsion constante entre le cantilever et l'échantillon afin de visualiser les informations de hauteur. Il peut également être utilisé pour mesurer la courbe de force.
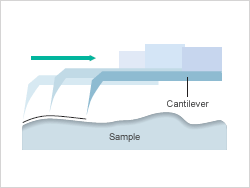 | 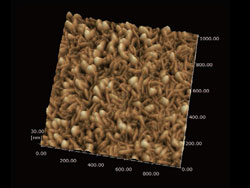 Film métallique fin |
Mode dynamique
Ce mode fait vibrer le cantilever à une fréquence proche de la fréquence de résonance et contrôle la distance dans la direction Z afin de maintenir l'amplitude de vibration constante et de visualiser la hauteur de l'échantillon. Il convient à des échantillons aux surfaces souples, tels que des polymères ou des matériaux visqueux.
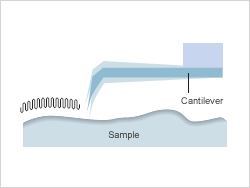 |  Surface en aluminium |
Mode phase
Ce mode détecte les retards de phase dans la vibration du cantilever lors du balayage en mode dynamique. Il peut observer les différences de propriétés physiques à la surface de l'échantillon.
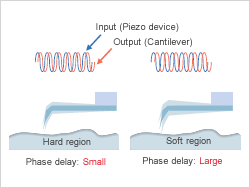 | 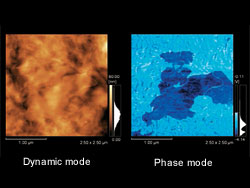 Film polymère |
Mode actif
Ce mode applique une tension de polarisation à l'échantillon afin de détecter et d'observer le courant circulant entre le cantilever et l'échantillon. Il peut également être utilisé pour les mesures I/V.
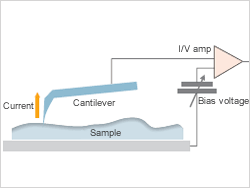 |  Échantillon de motifs de SiO2 sur un substrat de Si. La région en jaune sur l'image de la hauteur (à gauche) est SiO2. Elle est affichée en bleu (région sans courant) dans l'image en cours (à droite). Ces images montrent qu'un substrat présente des régions sans courant. |
Mode potentiel de surface (KFM)
Ce mode applique une tension c.a. à travers le cantilever conducteur, détecte la force électrostatique entre le cantilever et l'échantillon et visualise le potentiel électrique à la surface de l'échantillon. Il est également appelé « mode Kelvin Force Microscope » (KFM).
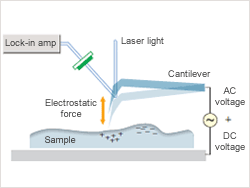 | 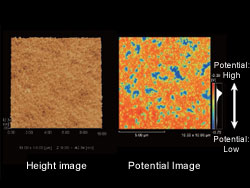 Échantillon de bande magnétique. L'image du potentiel de surface montre que la différence de potentiel de plusieurs centaines de mV est répartie sur la surface de l'échantillon. Cette répartition est considérée comme reflétant la présence d'irrégularités dans la couche de lubrification à la surface de la bande. |
Mode force magnétique (MFM)
Ce mode balaie la zone définie avec un cantilever magnétisé en mode phase et détecte les retards de phase dans la vibration du cantilever, puis visualise l'information magnétique à la surface de l'échantillon. Il est également appelé « mode Microscope à force magnétique » (MFM).
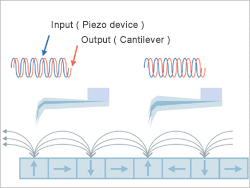 |  Échantillon de disque dur. L'image montre la répartition des propriétés magnétiques. |
Un LSM permet de manipuler de manière flexible plusieurs échantillons.
Imagerie de pentes allant jusqu'à 85°
Avec ses lentilles dédiées dotées de larges ouvertures numériques et son système optique dédié aux performances supérieures à celles d'un laser 405 nm, le microscope OLS4500 est capable de mesurer avec fiabilité des échantillons à angles aigus autrefois impossibles à mesurer.
 LEXT-Lentilles d’objectif dédiées | 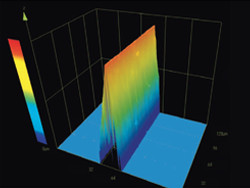 Rasoir avec un angle aigu |
Mesures haute résolution de micro profils
La lumière laser d’une longueur d'onde de 405 nm et la lentille de grande ouverture offrent une résolution X-Y de 0,12 μm. Le microscope OLS4500 est ainsi capable de mesurer la surface d'un échantillon submicronique. L’échelle linéaire très précise et la technologie de détection d'intensité Olympus renforcent le caractère haute définition des images pour des mesures précises de hauteurs submicroniques à plusieurs centaines de microns. De plus, le microscope OLS4500 est capable de garantir à la fois la « précision », qui indique la proximité d'une valeur de mesure de sa vraie valeur, et la « répétabilité », qui indique le degré de variations parmi des mesures répétées de valeurs. Ces deux caractéristiques démontrent la performance de l'outil de mesure.
 Motif linéaire et dans l'espace 0,12 μm |  (MPLAPON50XLEXT) STEP Hauteur standard Type B, PTB-5, Institut für Mikroelektronik, Allemagne, détection 6 nm de la mesure de la hauteur |
Dénomination de toute zone de capture d'image à partir d'une zone étendue
Bien que le champ de vision de l'image à fort grossissement soit généralement étroit, la fonction d'assemblage du microscope OLS4500 peut fournir des données d'image avec une haute résolution et un large champ de vision en assemblant jusqu'à 625 images. L'image à champ étendu ainsi obtenue peut faire l'objet d'un affichage 3D et de mesures 3D.
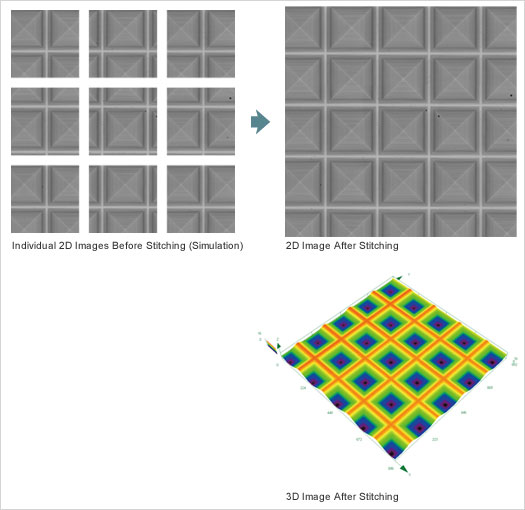
Mesure sans contact de la rugosité de surface de micro zones
Permet de mesurer la rugosité de surface en plus de la rugosité linéaire
 | Parce que la taille et le poids des produits industriels ne cessent de diminuer, les pièces qui les composent font également l'objet d'une miniaturisation. Cette tendance à la micro miniaturisation des composants réaffirme l'importance des mesures de la rugosité de surface et de la géométrie. Se faisant l’écho de cette évolution du marché, l'ISO a ajouté le LSM et l'AFM à la liste des instruments de mesure de textures de surface en 3D (ISO 25178-6). La mesure de la rugosité de surface sans contact est ainsi reconnue comme étant une norme d'évaluation officielle, tout comme la jauge traditionnelle de rugosité de surface par contact. Le microscope OLS4500 est livré avec des paramètres de rugosité conformes à la norme ISO. |
Mesure de la rugosité de surface afin de capturer des informations détaillées
Une mesure de la rugosité de surface sans contact permet d'obtenir la rugosité plane ainsi que la rugosité de ligne. La mesure de la rugosité plane peut également identifier la distribution et les propriétés de la rugosité dans la région définie, de sorte qu'elles puissent être réunies à l'image 3D à des fins d’évaluation. Le microscope OLS4500 peut mesurer la rugosité de surface à l’aide de la fonction LSM ou de la fonction SPM. Ces deux fonctions peuvent être sélectionnées selon les propriétés de l'échantillon ou l'objectif de l'observation.
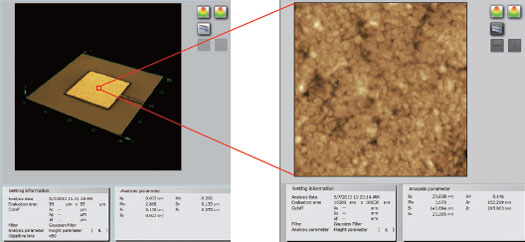 | |
| Mesure de la rugosité plane avec un LSM
(105 μm x 105 μm) Plot de connexion | Mesure de la rugosité plane avec un SPM
(10 μm x 10 μm) |
Paramètres LEXT du OLS4500
Compatibilité des paramètres
Le microscope OLS4500 est livré avec les mêmes paramètres de profil de surface que les jauges de rugosité de surface de contact. Il offre un fonctionnement et des résultats de mesure compatibles.
| Profil primaire | Pp, Pv, Pz, Pc, Pt, Pa, Pq, Psk, Pku, Psm, PΔq, Pmr(c), Pδc, Pmr |
| Profil de rugosité | Rp, Rv, Rz, Rc, Rt, Ra, Rq, Rsk, Rku, Rsm, RΔq, Rmr(c),Rδc, Rmr, RZJIS, Ra75 |
| Profil d'ondulation | Wp, Wv, Wz, Wc, Wt, Wa, Wq, Wsk, Wku, Wsm, WΔq, Wmr(c), Wδc, Wmr |
| Courbe de l'aire d'appui | Rk, Rpk, Rvk, Mr1, Mr2 |
| Motif | R, Rx, AR, W, Wx, AW, Wte |
| Profil de rugosité (JIS1994) | Ra(JIS1994), Ry, Rz(JIS1994), Sm, S, tp |
| Autres | R3z, P3z, PeakCount |
Prêt pour les paramètres de la prochaine génération
Le microscope OLS4500 est livré avec des paramètres de rugosité (3D) conformes à la norme ISO 25178. Grâce à l'évaluation de la zone plane, des analyses très fiables sont possibles.
| Paramètres d'amplitude | Sq, Ssk, Sku, Sp, Sv, Sz, Sa |
| Paramètres fonctionnels | Smr(c), Sdc(mr), Sk, Spk, Svk, SMr1, SMr2, Sxp |
| Paramètres volumétriques | Vv(p), Vvv, Vvc, Vm(p), Vmp, Vmc |
| Paramètres latéraux | Sal, Str |
Technologies de microscopie du OLS4500
Principes et fonctionnalités du microscope optique
Principes et caractéristiques du microscope à balayage laser
Le LSM (microscope à balayage laser) facilite les observations et les mesures submicroniques.
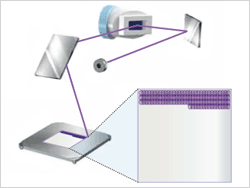 Balayage XY haute résolution d'un microscope laser (image copie d'écran) | La résolution plane X-Y d'un microscope optique dépend grandement de la longueur d’onde de la lumière utilisée. Le LSM utilise une lumière à faible longueur d’onde de sorte que la résolution plane X-Y est supérieure à celle d'un microscope traditionnel qui utilise la lumière visible. Le microscope OLS4500 intègre une lumière laser avec une longueur d’onde courte (405 nm) et une large ouverture dédiée. objectif et système optique confocal pour obtenir une résolution plane X-Y de 0,12 μm. Sa fonction de balayage XY, qui utilise un scanner 2D Olympus d'origine, assure un balayage de haute résolution de 4096 x 4096 pixels (max.). |
Capacité à mesurer de plus grandes hauteurs
Principes et caractéristiques d'un microscope à sonde à balayage
Un SPM (microscope à sonde à balayage) observe le monde à l'échelle du nanomètre
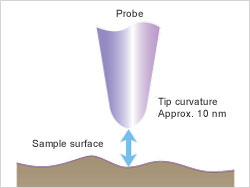 Principes d'un microscope à sonde | SPM est le nom générique des microscopes qui effectuent des observations 3D d'échantillons en approchant une petite sonde, d’une courbure de pointe d'environ 10 nm, vers la surface de l'échantillon et en balayant l'échantillon tout en détectant les interactions dynamiques et électriques entre la sonde et l'échantillon. Un des SPM typiques est l'AFM (microscope à force atomique) qui produit des images de la texture de surface de l'échantillon en détectant les forces attractives et répulsives entre la sonde et la surface de l'échantillon. Une observation à l'échelle du nanomètre permet de saisir finement la texture de surface. |
Observation nanométrique par balayage du cantilever
 Pas optique du capteur du SPM | Le microscope OLS4500 utilise un système de levier optique capable de détecter la micro déviation (déplacement) du cantilever portant la sonde sur la pointe avec une haute sensibilité. En réfléchissant le faisceau laser à l'arrière du cantilever et en l'entraînant selon l'axe Z à l'aide d'un dispositif piezo, le faisceau atteint le point spécifié sur le photodétecteur pour que le système puisse lire un minuscule déplacement dans la direction Z. |
Différents modes d'imagerie des textures de surface et des propriétés physiques
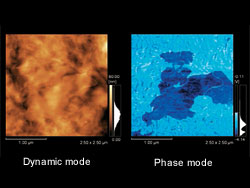 Film polymère | Le mode sonde à balayage intègre différents modes d'observation de la texture et de mesure de la surface d'un échantillon, ainsi que d'analyse des propriétés physiques. Le microscope OLS4500 offre les modes suivants.
|
Cantilever : la clé pour avoir une image haute définition et de qualité
La sonde est placée sur la pointe d'un cantilever de type feuille d'environ 100 à 200 μm de long. La constante du ressort et la fréquence de résonance du cantilever sont choisies en fonction des caractéristiques de l'échantillon. Étant donné que la sonde s'use après des balayages répétés, la pointe du cantilever doit être remplacée régulièrement ou lorsque nécessaire.

Cantilever
Large gamme de cantilevers développés par Olympus
La résolution dans le plan X - Y du SPM est déterminée par le diamètre de la pointe de la sonde.Les cantilevers développés et fabriqués par Olympus garantissent une stabilité de la qualité de la pointe de la sonde pour une grande fiabilité.Des conceptions uniques, telles que la structure « TipView », facilitent le positionnement précis de la sonde tandis que le « nouveau concept de circuit
intégré » améliore l'ergonomie ainsi que la précision.
*Un catalogue de cantilevers est disponible séparément.
OMCL-AC160TS-C3 Cantilever standard en silicium
Facteur Q élevé pour des mesures haute résolution
Largement utilisé dans les mesures en mode dynamique.Il convient pour la mesure de la rugosité des surfaces.
OMCL-AC240TS-C3 Cantilever en silicium moyennement souple
Mesure de la viscoélasticité avec une reproductibilité élevée
La constante du ressort de 2 N/m (Nom.) est inférieure à celle des pieds à coulisse en silicium de la série AC.Cela convient donc aux mesures de la viscoélasticité des échantillons souples.
OMCL-TR800PSA-1 Cantilever standard en nitrure de silicium
Faible usure, excellente durabilité
Largement utilisé dans les mesures en mode contact, en raison de la souplesse du pied à coulisse et de la résistance à l’usure de la sonde.Chaque puce dispose de deux cantilevers de longueur différente de 100 μm et 200 μm.
Compatible avec une large gamme de cantilevers, remplacement facile et précis du cantilever
Le cantilever peut devoir être remplacé en fonction de la fréquence d'utilisation.La tourelle porte-objectifs motorisée rotative, la tête du scanner SPM et le pied à coulisse étant alignés avec précision, il suffit d’insérer le support du cantilever aligné dans la tête du scanner SPM pour remplacer le cantilever.L’outil d'alignement fourni avec le système pour aider au positionnement du cantilever et du support et faciliter la précision du réglage, quel que soit l’utilisateur.D'autres types de pieds à coulisse peuvent être remplacés en suivant la même procédure. Les observations et les mesures en deviennent ainsi plus efficaces.
 Outil d'alignement pour le positionnement du cantilever | 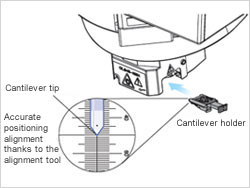 |
Caractéristiques techniques
Unité principale
| Section LSM > Source lumineuse / Détecteur | Source lumineuse : 405 nm laser semi-conducteur, Détecteur : photomultiplicateur |
|---|---|
| Section LSM > Grossissement total | 108x – 17 280x |
| Section LSM > Zoom | Zoom optique : 1x – 8x |
| Section LSM > Mesure > Mesure plane > Répétabilité | 100x : 3σn-1=0,02 μm、50x:3σn-1=0,04 μm、20x:3σn-1=0,1 μm |
| Section LSM > Mesure > Mesure plane > Précision | Valeur de mesure ±2 % |
| Section LSM > Mesure > Mesure de la hauteur > Système | Système d’entraînement vertical de la tourelle porte-objectifs rotative |
| Section LSM > Mesure > Mesure de la hauteur > Course | 10 mm |
| Section LSM > Mesure > Mesure de la hauteur > Résolution de l'échelle | 0,8 nm |
| Section LSM > Mesure > Mesure de la hauteur > Résolution du déplacement | 10 nm |
| Section LSM > Mesure > Mesure de la hauteur > Résolution de l'affichage | 1 nm |
| Section LSM > Mesure > Mesure de la hauteur > Répétabilité | 100x : σn-1= 0,012 μm、50x :σn-1=0,012 μm、20x :σn-1=0,04 μm |
| Section LSM > Mesure > Mesure de la hauteur > Précision | 0,2+L/100 μm ou moins (L=Longueur de mesure) |
| Section LSM > Section d'observation de la couleur > Source lumineuse / Détecteur | Source lumineuse : LED blanche, Détecteur : 1/1,8-pouce 2-Megapixel CCD simple panneau |
| Section LSM > Section d'observation de la couleur > Zoom | Zoom numérique : 1x – 8x |
| Section LSM > Tourelle porte-objectifs rotative | Tourelle porte-objectifs sextuple rotative BF motorisée |
| Section LSM > Unité de Contraste d'interférences différenciées | Curseur de réglage de contraste d'interférences différenciées : U-DICR, Plaque polariseur intégrée |
| Section LSM > Lentille d'objectif | Plan semi-apochromatique BF 5x, plan apochromatique dédié au LEXT 20x, 50x, 100x |
| Section LSM > Course unité de mise au point Z | 76 mm |
| Section LSM > Platine XY | 100 x 100 mm (Platine motorisée) |
| Section SPM > Mode de mesure | mode contact, mode dynamique, mode phase, mode actuel*, mode potentiel de surface (KFM)*, mode force magnétique (MFM)* |
| Section SPM > Déplacement de déplacement | Système de levier optique |
| Section SPM > Source lumineuse | Laser Semi-conducteur 659 nm |
| Section SPM > Détecteur | Photodétecteur |
| Section SPM > Étendue de balayage max. | X-Y : Max. 30 μm x 30 μm、Z : Max. 4,6 μm |
| Section SPM > Montage du cantilever | Montage utilisant un support de cantilever de type cassetteEn raison de l'alignement préalable avec l'outil spécial dédié au montage du cantilever, il n’est pas nécessaire d’effectuer un alignement optique lors du remplacement du cantilever. |
| Système > Poids total | Env. 440 kg (sans la table) |
| Système > Tension nominale d'entrée | 100 - 120 V/220 - 240 V, 600 VA, 50/60 Hz |
* En option
Lentille d'objectif
| Modèle | Grossissement | Champ d'observation | Distance frontale (WD) | Ouverture numérique (NA) |
| MPLFLN5X | 108-864X | 2 560-320 μm | 20,0 mm | 0,15 |
| MPLAPON20XLEXT | 432-3 456X | 640-80 μm | 1,0 mm | 0,60 |
| MPLAPON50XLEXT | 1 080-8 640X | 256-32 μm | 0,35 mm | 0,95 |
| MPLAPON100XLEXT | 2 160-17 280X | 128-16 μm | 0,35 mm | 0,95 |
Cantilever
Application (Utilisation) | Nom du produit | Type | Numéro du circuit intégré | Cantilever | Sonde | Matériau | Revêtement métallique | ||
| Fréquence de résonance (kHz) | Constante du ressort (N/m) | Hauteur (μm) | Rayon (nm) | Sonde / Levier | Côté de la sonde / Côté Reflex | ||||
| Mode dynamique / Mode phase | OMCL-AC160TS-C3 | Silicium standard | 24 | 300 | 26 | 14 | 7 | Si / Si | Non / Al |
| OMCL-AC240TS-C3 | Silicium moyennement souple | 24 | 70 | 2 | 14 | 7 | Si / Si | Non / Al | |
| Mode contact | OMCL-TR800PSA-1 | Nitrure de silicium standard | 34 | 73 / 24 | 0.57 / 0.15 | 2,9 | 7 | SiN / SiN | Non / Au |
| Mode potentiel de surface | OMCL-AC240TM-B3 | Silicium pour mesure électrique | 18 | 70 | 2 | 14 | 15 | Si / Si | Pt/Al |
• Les dimensions et les propriétés mécaniques ci-dessus sont des valeurs types.
• Attention, les cantilevers sont très petits et peuvent donc tomber, être projetés dans les yeux ou être ingérés accidentellement.
• Pour obtenir des informations sur la manière d'utiliser les cantilevers dans le mode actuel et le mode force magnétique, veuillez contacter votre revendeur Olympus.
• Outre ceux présentés ici, un grand nombre de cantilevers sont disponibles chez Olympus. Veuillez contacter votre revendeur Olympus pour en savoir plus.
Applications
 Impression couleur Microscope optique (50x) |  Impression couleur SPM (Zone de balayage : 5 μm x 5 μm, image 3D) |
 Bactéries lactiques LSM (Zone de balayage : 100 μm x 100 μm) |  Bactéries lactiques SPM (Zone de balayage : 20 μm x 20 μm, image de la hauteur) |
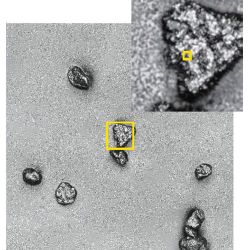 Particules de toner LSM (Zone de balayage : 80 μm x 80 μm, en haut à droite : 10 μm x 10 μm) |  Particules de toner SPM (Zone de balayage : 1 μm x 1 μm, image 3D) |