A formação de imagem de infravermelho próximo (NIR) usando um microscópio pode formar imagens através do silício com até 650 μm de espessura, tornando-a uma forma eficaz de inspecionar componentes eletrônicos e semicondutores. Um protocolo de análise de falhas típico da microeletrônica exige a habilidade de inspecionar, de forma não destrutiva, os padrões de circuitos através do silício, mantendo a integridade mecânica do produto acabado.
As inspeções de componentes eletrônicos típicas usando a formação de imagem de NIR incluem:
- Inspeção de curtos-circuitos no interior do produto (por exemplo, marcas de queimadura, indicadores de tensão)
- Alinhamento da soldagem (análise das marcas de alinhamento entre circuitos ligeiramente soldados e do alinhamento dos wafers soldados)
- Inspeção após os testes elétricos (qualquer tipo de falha)
- Avaliação de danos no chip (por exemplo, defeitos nos materiais, contaminação)
- Inspeção de sistemas microeletromecânicos (MEMS), como a estrutura do dispositivo no interior do wafer soldado, detecção de vazios e defeitos e formação de imagem do movimento mecânico em tempo real
Continue lendo para explorar exemplos de como a formação de imagem de NIR é usada para as inspeções de componentes eletrônicos e semicondutores. Além disso, saiba mais sobre os microscópios industriais, câmeras digitais e objetivas que suportam a formação de imagem de NIR nessas aplicações.
Exemplos de como a formação de imagem de NIR é usada para inspeções de componentes eletrônicos e semicondutores
A formação de imagem de NIR permite realizar inspeções com microscópio de peças eletrônicas que não podem ser observadas visualmente. Veja a seguir algumas formas eficazes de uso da formação de imagem de NIR em inspeções industriais:
1. Inspecionar danos no chip em encapsulamento do tamanho do chip (CSP) em nível do wafer.
Um encapsulamento do tamanho do chip em nível do wafer é um encapsulamento de circuito integrado no nível do wafer. A formação de imagem de NIR usando um microscópio pode ser usada para inspecionar de forma não destrutiva os danos no chip que ocorrem durante os testes de calor e umidade. Um microscópio de IR pode formar imagens através do silício para que você possa observar vazamentos da fusão, corrosão da fiação de cobre, descascamento das peças de resina e outros problemas.
2. Realizar uma análise flip-chip não destrutiva.
Como o nome sugere, o flip-chip é um método de encapsulamento do chip no qual a área ativa do chip é invertida e montada diretamente em um substrato, placa ou transportador. Uma vez que o flip-chip é soldado na peça, o padrão do chip não pode ser inspecionado usando luz visível. Por outro lado, um microscópio de IV permite observar através do silício para verificar o interior quanto a defeitos sem destruir o chip montado. Essa também é uma forma eficaz de identificar as áreas que devem ser submetidas ao processamento de feixe de íons focalizado (FIB).
3. Determinar a quantidade de moagem do wafer.
A moagem do wafer é uma etapa de fabricação de dispositivos semicondutores que reduz a espessura do wafer. O afinamento de dispositivos por meio da moagem aumenta a necessidade de medir ambos os lados dos wafers. No entanto, é extremamente difícil medir a quantidade de moagem em ambos os lados dos wafers laminados. Um sistema de microscópio de IV pode formar imagens através do material para focar na parte frontal ou traseira do wafer, permitindo obter a distância geral. Assim, você pode determinar a extensão da moagem medindo a quantidade de movimento Z da objetiva.
4. Determinar o espaçamento do chip em configurações de montagem 3D.
Os microscópios de IV também podem auxiliar no gerenciamento do espaçamento do silício. O espaçamento do chip em uma configuração de montagem tridimensional (3D) pode ser determinado de forma não destrutiva medindo a quantidade de movimento da objetiva quando a luz IV passa através do silício e foca no chip e no interposer. Este método também pode ser usado na medição e fabricação oca de dispositivos de MEMS.
5. Formar imagens de várias amostras difíceis.
As imagens de infravermelho de ondas curtas (SWIR) em comprimentos de onda mais longos – por exemplo, na faixa de 1.300–1.500 nm – permite formar imagens de amostras mais difíceis, como dispositivos de MEMS, amostras de silício com dopagem pesada, amostras com superfícies rugosas, soldagem de wafer e pilhas de chip 3D. Este método é viabilizado usando sistemas de formação de imagem mais sensíveis, como câmeras de arseneto de gálio e índio (InGaAs). Os benefícios no sinal das objetivas de IV dedicadas, a iluminação de alta potência e as câmeras de InGaAs durante a microscopia de luz refletida ou transmitida permitem formar imagens dessas amostras mais difíceis.
Ferramentas para a formação de imagem de NIR: microscópios industriais, câmeras de infravermelho próximo e mais
Uma variedade de ferramentas está disponível para possibilitar a formação de imagem de infravermelho próximo em laboratórios de controle de qualidade e de pesquisa e desenvolvimento (R). Isso inclui:
1. Microscópios de IV de luz transmitida
A microscopia de luz refletida é ideal para a iluminação de uma amostra de cima. Em comparação, a microscopia de IV de luz transmitida ilumina uma amostra através do silício por debaixo da amostra, fornecendo um contraste maior. A microscopia de luz transmitida é especialmente útil para inspecionar os padrões de alinhamento ou marcas de referência através do silício.
Nosso microscópio MX63 oferece observação IV de luz transmitida para inspeções não destrutivas de defeitos no interior de chips IC e outros dispositivos eletrônicos fabricados com silício ou vidro que transmitem facilmente os comprimentos de onda de IV da luz.

Microscópio de inspeção MX63 para semicondutores e monitores de tela plana
2. Câmeras de infravermelho próximo
As câmeras digitais para microscópio podem fornecer imagens de alto contraste ao longo de todo o espectro do NIR até 1.100 nm mantendo ao mesmo tempo um grande campo de visão. Nossa câmera para microscópio monocromática DP23M combinada com um filtro passa-banda (BP) de 1.100 nm oferece uma resposta espectral ampla da luz visível até 1.100 nm, tornando a câmera ideal para a formação de imagem de NIR. Com uma resolução de 6,4 megapixels, a câmera fornece imagens de microscopia de infravermelho e em escala de cinza confiáveis e de alta qualidade.
Veja alguns exemplos abaixo:
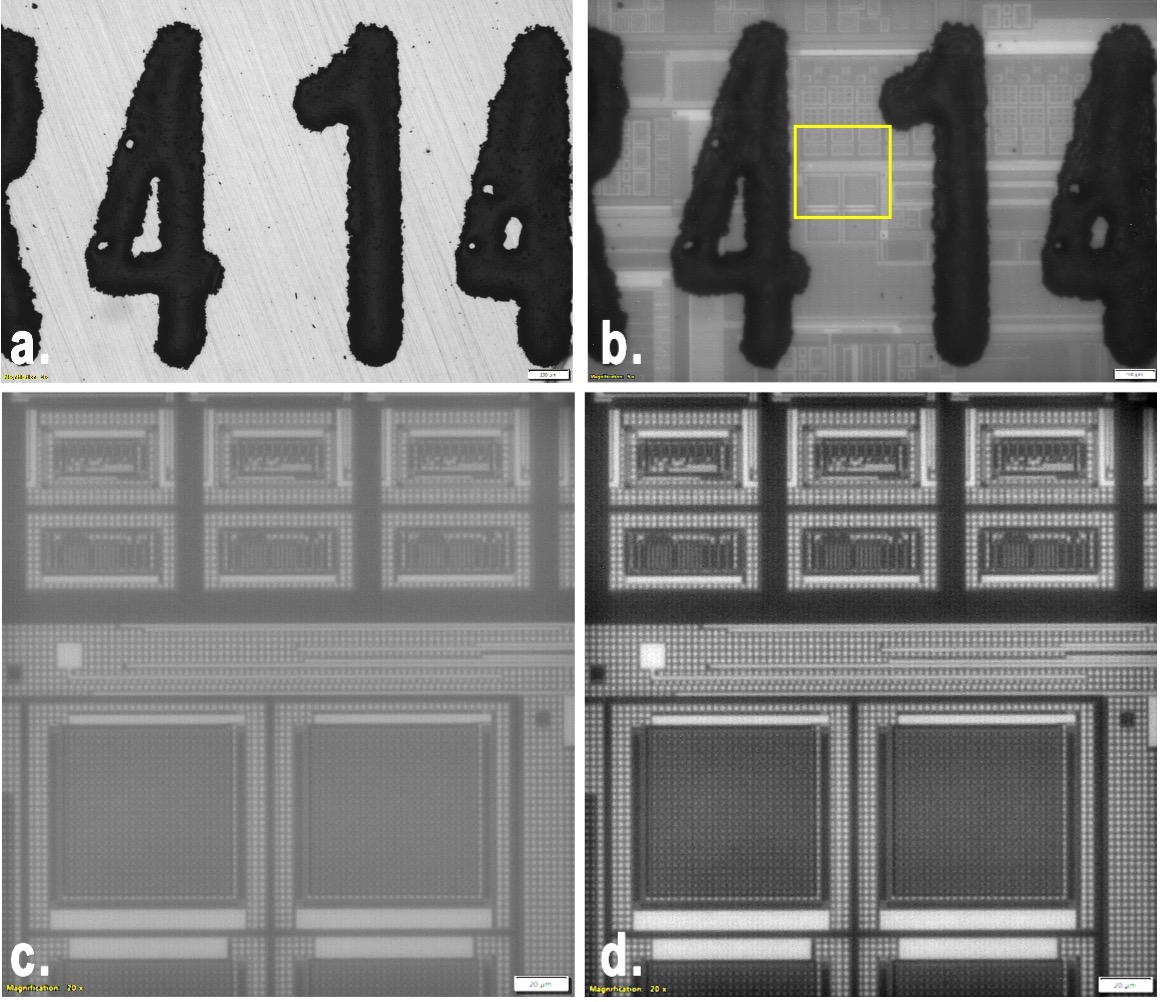
Imagens de um chip semicondutor capturadas usando a câmera digital para microscópio DP23M. A) Imagem de campo claro de 5X. B) Imagem de IV de 5X (filtro BP de 1100 nm). C) IV de detalhe cortado de 20X. D) IV de detalhe cortado de 20X com um filtro de melhoria de contraste diferencial (DCE).

Imagem de IV de transmissão (10X) de um chip semicondutor. Capturada usando a câmera digital para microscópio DP23M.

Imagem de campo claro (10X) do mesmo chip semicondutor mostrado acima. Capturada usando a câmera digital para microscópio DP23M.

Fornecendo o contraste melhorado na amostra, uma imagem de sobreposição em cores falsas representa as áreas mais claras e as áreas mais escuras do chip semicondutor. Campo claro (azul ciano) e IV de transmissão (magenta). Capturada usando a câmera digital para microscópio DP23M.
3. Lentes objetivas de infravermelho próximo
As lentes objetivas de NIR mais recentes podem fornecer uma maior transmitância no espectro do NIR. Os colares de correção das nossas objetivas LCPLN-IR de 20X, 50X e 100X podem ser configuradas para uma espessura de silício específica para proporcionar uma melhor transmitância, contraste e correção de aberração.

Objetivas LCPLN-IR para inspeção de estruturas internas em wafers de silício
4. Software de análise de imagens
A maioria dos laboratórios R e de análise de falhas demanda uma abordagem digital para medir defeitos, criar relatórios e arquivar imagens. Devido à natureza dessa aplicação (formação de imagem através do material com luz baixa), o contraste nativo é mínimo e deve ser otimizado através do software de análise de imagens. Uma iluminação irregular resultante, por exemplo, da vinheta, escurece os cantos da imagem em relação ao centro. Isso deve ser removido digitalmente da visualização em tempo real e da imagem capturada.
O software dedicado pode resolver esses problemas, fornecendo:
- Correção do sombreamento em tempo real para maximizar a uniformidade da imagem em todo o campo de visão
- Medições precisas em qualquer lugar dentro do campo de visão
- Relatórios gerados automaticamente
- Arquivamento de imagens e dados relevantes
As nossas câmeras digitais e microscópios de IV se integram com o software de imagem e medição PRECiV™para criar um processo de trabalho de inspeção simplificado, da formação de imagem à elaboração de relatórios. Para saber mais sobre as nossas soluções de formação de imagem de NIR, entre em contato com os nossos especialistas hoje.
Conteúdo relacionado
Câmera para microscópio industrial DP23M
Controle de qualidade em fabricação de componentes eletrônicos com o software PRECiV


