顕微鏡を使用した近赤外線(NIR)イメージングは、厚さ650 μmまでのシリコンを撮像可能で、電子機器や半導体の優れた検査手段となっています。マイクロエレクトロニクスの標準的な故障解析手順では、シリコンを通して回路パターンを非破壊で検査する能力とともに、完成品の機械的健全性を維持することが求められます。
NIRイメージングを使用する標準的な電子機器検査には、以下があります。
- 製品内のショートの検査(熱損傷跡、圧力インジケーターなど)
- ボンディングアライメント(細かく接合される回路間にあるアライメントマークや、接合したウエハーのアライメントの解析)
- 電気試験後の検査(あらゆる種類の故障)
- チップ損傷の評価(材料の欠陥、コンタミネーションなど)
- 微小電気機械システム(MEMS)の検査(接合したウエハー内デバイスの構造、ボイドや欠陥の検出、機械的動作のライブイメージングなど)
電子機器と半導体の検査に使用するNIRイメージングの例についてご紹介します。また、これらの用途におけるNIRイメージングをサポートする工業用顕微鏡、デジタルカメラ、対物レンズについてもご紹介します。
電子機器と半導体検査におけるNIRイメージングの活用例
NIRイメージングでは、目視では確認できない電子部品の顕微鏡検査が可能です。工業検査におけるNIRイメージングの優れた使用法をご紹介します。
1. ウエハーレベルチップスケールパッケージ(CSP)のチップ損傷を検査する
ウエハーレベルチップスケールパッケージは、ウエハーレベルに組み込まれた回路パッケージです。顕微鏡を用いたNIRイメージングにより、熱や湿度による試験中に発生するチップ損傷を非破壊で検査することができます。IR顕微鏡はシリコンを透過して撮像可能なので、融解からの漏れ、銅配線の腐食、樹脂部品のはがれなどの問題を観察できます。
2. フリップチップの非破壊解析を実施する
名前が示すとおり、フリップチップはチップの有効領域を裏返して、基板やキャリアに直接取り付けるチップパッケージ法です。フリップチップをパーツに接合すると、チップパターンは可視光で検査できなくなります。それに対してIR顕微鏡を使用すると、取り付けたチップを壊すことなく、シリコンを透過して内部まで欠陥の有無を観察できます。この方法では、集束イオンビーム(FIB)処理を施す必要がある領域を効果的に識別することもできます。
3. ウエハー研削の量を測定する
ウエハー研削は、ウエハーの厚さを低減する半導体機器加工工程です。研削による機器の薄型化により、ウエハーの両側を測定する必要性が高まっています。しかしながら、積層ウエハーの両側の研削量を測定するのは非常に困難です。IR顕微鏡システムでは、材料を透過してウエハーの前面と後面に焦点を合わせて撮像可能なので、全体の距離を把握することができます。したがって、対物レンズのZ移動量を測定すれば、研削の程度を判断できます。
4. 3D実装時のチップギャップを決定する
IR顕微鏡はシリコン間隙の管理にも役立ちます。三次元(3D)実装構成のチップギャップは、IR光がチップとインターポーザーを通って焦点を当てるときに、対物レンズの動きの幅を測ることで非破壊的に決定できます。この方法はMEMS機器の測定と中空構造にも使用できます。
5. さまざまな難しいサンプルを撮像する
長波長域での短波長赤外(SWIR)イメージング(例えば1300~1500 nmの範囲)は、MEMSデバイス、高濃度にドープされたシリコンサンプル、表面が粗いサンプル、ウエハー接合、3Dチップスタックなどの難しいサンプルを撮像できます。この方法には、インジウム・ガリウム・ヒ素(InGaAs)カメラなどの感度の高いイメージングシステムを使用します。落射型顕微鏡や透過型顕微鏡では、専用のIR対物レンズ、高出力照明、InGaAsカメラによる信号の恩恵で、より難しいサンプルのイメージングが可能です。
NIRイメージング用のツール:工業用顕微鏡、近赤外線カメラなど
品質管理や研究開発ラボの近赤外線イメージングには、以下のように、さまざまなツールを使用できます。
1. 透過型IR顕微鏡
落射型顕微鏡はサンプルに上から照明を当てる場合に理想的です。これに対し、透過型赤外顕微鏡は、サンプルの下からシリコンを通してサンプルに光を当てるため、より高いコントラストを得ることができます。透過観察が特に有用なのは、シリコンを通してアライメントパターンや基準マークを検査する場合です。
当社のMX63顕微鏡では透過IR観察が可能で、IR波長光を通しやすいシリコン製またはガラス製ICチップやその他の電子機器の内部欠陥を非破壊で検査できます。

半導体およびフラットパネルディスプレイ検査用のMX63顕微鏡
2. 近赤外線カメラ
顕微鏡用デジタルカメラは、広視野を維持したまま、最大1100 nmのNIRスペクトル全体で高コントラスト画像を撮影可能です。当社のDP23Mモノクロカメラを1100 nmバンドパス(BP)フィルターと組み合わせると、最大1100 nmの可視光からの広いスペクトル応答が得られるので、NIRイメージングに適しています。640万画素の解像度により、信頼性のある高品質グレースケール画像や赤外線観察画像を取得できます。
以下にいくつかの例を示します。
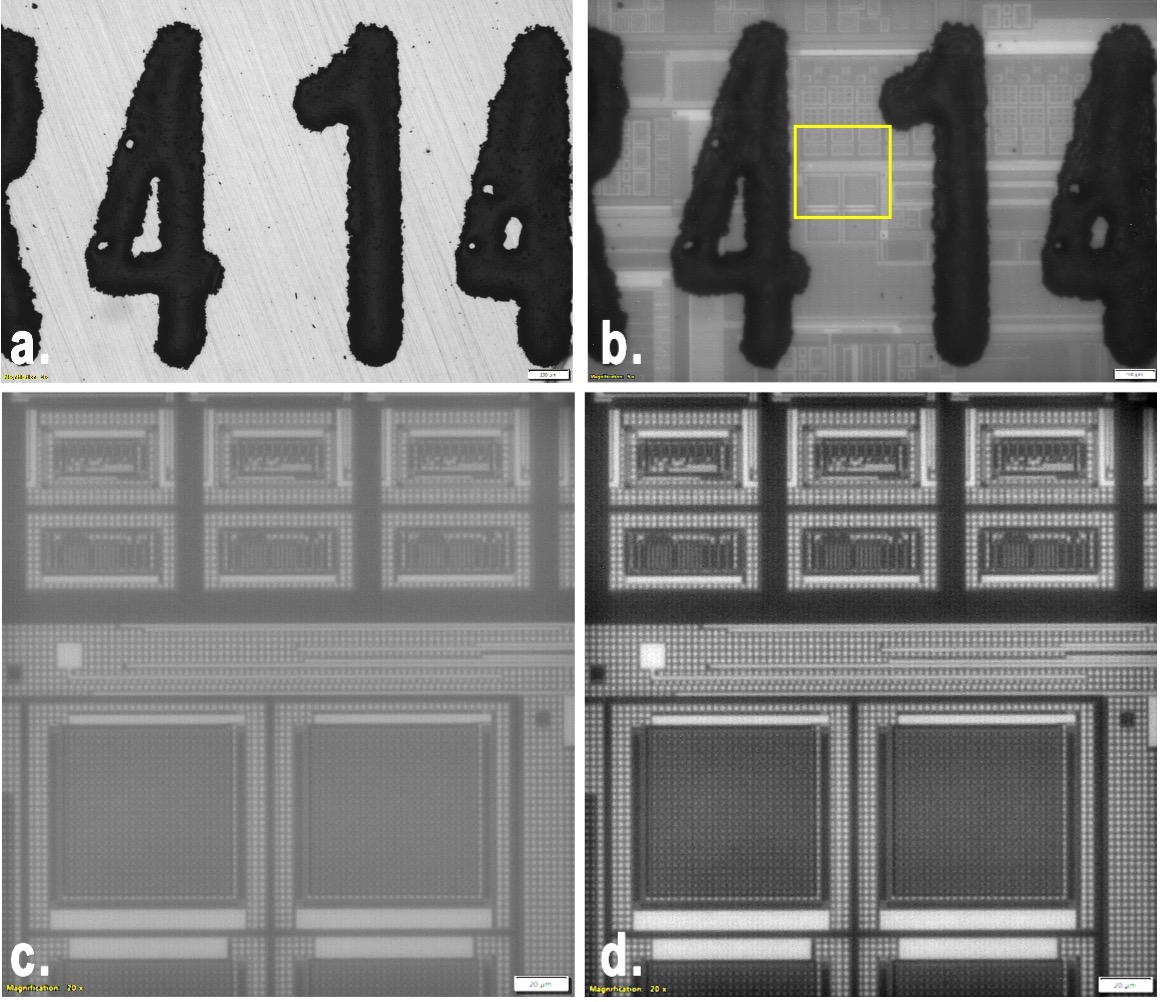
顕微鏡用デジタルカメラDP23Mで撮影した半導体チップの画像。A)5倍明視野画像B)5倍IR画像(BP1100 nmフィルタ-)C)トリミングした20倍IR画像D)トリミングした20倍IR画像、差分コントラスト強調(DCE)フィルター使用

半導体チップの透過IR画像(10倍)。顕微鏡用デジタルカメラDP23Mを使用して撮影。

上に示したものと同じ半導体チップの明視野画像(10倍)。顕微鏡用デジタルカメラDP23Mを使用して撮影。

サンプルのコントラストを強調する疑似カラーのオーバーレイ画像に、半導体チップの明るい領域と暗い領域が示されている。明視野(シアンブルー)と透過IR(マゼンタ)。顕微鏡用デジタルカメラDP23Mを使用して撮影。
3. 近赤外線対物レンズ
最新のNIR対物レンズでは、NIRスペクトルの透過性が向上しています。当社のLCPLN-IR 20X、50X、および100X対物レンズに付属の補正環は、特定のシリコンの厚さに合わせて透過性、コントラスト、収差補正が向上するように設定できます。

シリコンウエハーの内部構造検査用LCPLN-IR対物レンズ
4. 画像解析ソフトウェア
ほとんどの故障解析やラボでは、欠陥の測定、レポート作成、画像の保管へのデジタル化を必要としています。この用途の性質上(低照度でサンプルを通しての撮影)、自然のコントラストはわずかであるため、画像解析ソフトウェアで最適化する必要があります。口径食などにより照明が不均一に当たると、画像の中心に比べて隅が暗くなります。これはライブ表示や取得画像からデジタル的に除去する必要があります。
これらの課題は専用ソフトウェアで以下のように解決できます。
- 視野全体の画像均一性を最大限にするライブシェーディング補正
- 視野内のどこでも的確に測定
- レポートの自動作成
- 画像と関連データの保管
当社のIR顕微鏡とデジタルカメラを、PRECiV™ イメージング・測定ソフトウェアと組み合わせて、イメージングからレポート作成までのシームレスな検査ワークフローを実現します。NIRイメージングの当社ソリューションの詳細は、専門スタッフにお問い合わせください。


