顕微鏡ソリューション
半導体製造工程
- ホーム
- 顕微鏡ソリューション 半導体製造工程
- ワイヤボンディング
ワイヤボンディング
ワイヤーボンディングは、ICチップとリードフレームを接続する工程です。 ICチップは外部デバイスにワイヤーボンディングで接続されます。 リードフレームとICチップのアルミパッドにワイヤーを付け、圧力、超音波、熱を組み合わせて溶接します。
オリンパスはリードフレームに関して様々な解決策を提供いたします。ボンディングワイヤーやメッシュボール等。
リードフレームの表面状態の解析
ICチップとリードフレームのインナーリードをボンディングワイヤーで接続します。 リード表面が不均一だと、ワイヤの接着不良を引き起こすため、リードの表面粗さ管理が重要になります。
私たちのソリューション
OLSシリーズは、微細なリード表面のデータも取得し、粗さを測定する事が出来ます。 リードフレームの粗さはR-ratioで管理されるケースが多いです。
3D測定レーザー顕微鏡 OLS 5000 | 光学顕微鏡画像 |  表面粗さ |
アプリケーションノート
関連アプリケーションの詳細情報をご参照ください。
| |||
| |||
|
ボンディング後のボールの位置チェック
アルミパッドの決まった位置にマッシュボール(ボンディングワイヤーのボール状の端)を溶着ます。 マッシュボールがパッドの外にある場合、ボンディングマシンの条件を調整しなければいけません。そのためマッシュボールの位置ズレを確認する必要があります。
私たちのソリューション
測定顕微鏡STM7は、マッシュボールの位置ズレを高精度に測定できます。
測定顕微鏡 | 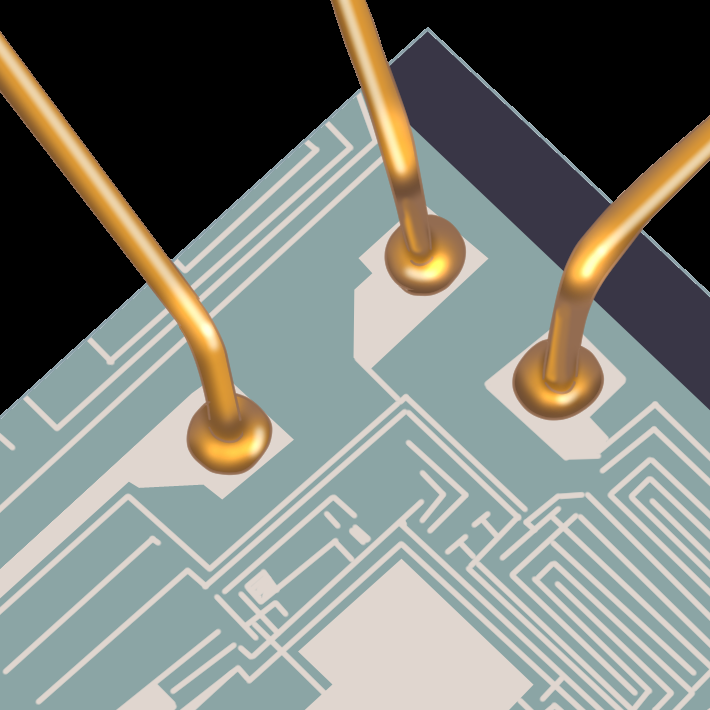 マッシュボール | パッドの外側に溶着されるボール |
アプリケーションノート
関連アプリケーションの詳細情報をご参照ください。
| |||
| |||
 |
|
ワイヤループの高さ測定
ボンディングワイヤがICチップまたはパッケージに接触するとショートが発生するため、ワイヤループの高さを制御する必要があります。 ワイヤーループの高さ測定は、ワイヤーが非常に細く、ワイヤーループが非常に細いため、安いコストで実施する方法は多くありません。 また、ワイヤーやICチップは非接触で測定する必要があります。
私たちのソリューション
高倍率レンズ付きの測定顕微鏡STM7(長作動距離タイプ、50倍以上)は、ループ高さを正確に測定できます。
オートフォーカスやフォーカスナビゲーター機能などのオプションアイテムは、測定の効率と精度をさらに向上させることができます。
測定顕微鏡 | ボンディングワイヤの |
アプリケーションノート
関連アプリケーションの詳細情報をご参照ください。
| |||
| |||
 |
|
ボンディングワイヤの欠陥のチェック
ボンディングワイヤーの幅は15〜30umと細く、ワイヤボンディングのわずかな不具合でも、導電性に悪影響を与えます。 ワイヤーの小さな不具合は目視検査では検出が非常に困難です。
私たちのソリューション
デジタルマイクロスコープDSX1000は、ボンディングワイヤの亀裂や傷などの小さな欠陥の検出に適しています。
デジタルマイクロスコープ | 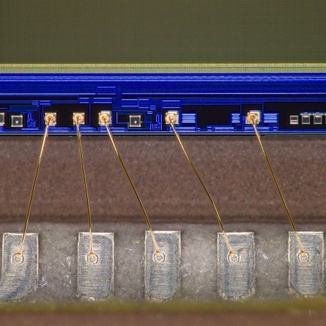 ボンディングワイヤ 75X | 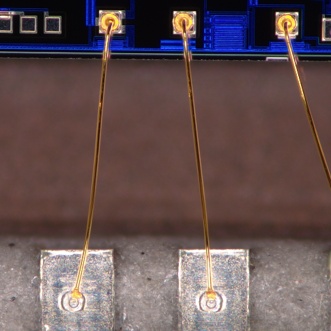 ボンディングワイヤ 150X |
アプリケーションノート
関連アプリケーションの詳細情報をご参照ください。
| |||
| |||
|
アルミパッドのスプラッシュのチェック
アルミパッドのスプラッシュは超音波溶接の際発生します。スプラッシュが隣のパッドやボールとパッド間の接続領域に触れると、ショートの原因になります。 その場合、スプラッシュを抑えるために超音波溶接機の設定を変更する必要があります。
この検査にはSEM(走査型電子顕微鏡)が使用されるケースが多いですが、チェックに時間がかかります。
私たちのソリューション
OLS5000はアルミパッドからのスプラッシュ形状を確認する事ができます。 干渉計ではスプラッシュを検出することは困難です。
3D測定レーザー顕微鏡 |  |
アプリケーションノート
関連アプリケーションの詳細情報をご参照ください。
| |||
| |||
 |
|
溶接エリアのボイドと腐食のチェック
溶接部のボイドや腐食は導電性に悪影響を与えるため、それらの有無を確認する必要があります。 ボイドや腐食が見つかった場合は、溶接機の設定を調整する必要があります。
この検査にはSEM(走査型電子顕微鏡)が使用されるケースが多いですが、チェックに時間がかかります。
私たちのソリューション
OLSは前処理不要で最大9,000Xの撮影がスピーディーに行えるため、溶接領域の断面をすばやく観察できます。
3D測定レーザー顕微鏡 |  溶接エリアのボイド |
アプリケーションノート
関連アプリケーションの詳細情報をご参照ください。
| |||
| |||
|
赤外線 (IR)検査
フリップチップはICチップの一種で、裏面に電極端子があります。 プリント回路基板上の取り付けスペースを削減する目的で組み込まれています。
フリップチップのボンディングとICパターンの状態は、パッケージング後は外から確認することができません。しかし、不適切なボンディングと損傷したICパターンは誤動作の原因になります。
私たちのソリューション
BXおよびMXシリーズのIRイメージングシステムでは、シリコンのIR透過特性により、パッケージ後のフリップチップの非破壊内部観察が可能です。 この検査方法は、MEMSウェーハにも使用されています。
工業顕微鏡 | 半導体検査顕微鏡 | フリップチップ実装 |
アプリケーションノート
関連アプリケーションの詳細情報をご参照ください。
| |||
| |||
|
工業顕微鏡 BX | 半導体検査顕微鏡 MX |
