Mit der Nahinfrarot-Bildgebung (NIR) eines Mikroskops können Aufnahmen durch Silizium mit einer Dicke von bis zu 650 µm gemacht werden, was diese Technik zu einem leistungsstarken Werkzeug für die Prüfung von elektronischen Bauteilen und Halbleitern macht. Ein typisches Fehleranalyseprotokoll für die Mikroelektronik erfordert die Möglichkeit einer zerstörungsfreien Prüfung von Schaltungsmustern durch Silizium unter Beibehaltung der mechanischen Integrität des Endprodukts.
Typische Prüfungen von elektronischen Bauteilen mit NIR-Bildgebung umfassen:
- Prüfung auf Kurzschlüsse im Produkt (z. B. Brennspuren, Stressindikatoren)
- Bond-Ausrichtung (Analyse von Ausrichtungsmarkierungen zwischen dünn gelöteten Schaltungen)
- Prüfung nach der elektrischen Prüfung (jede Art von Fehler)
- Prüfung auf Beschädigungen von Chips (z. B. Materialfehler, Verschmutzung)
- Prüfung von mikroelektromechanischen Systemen (MEMS), wie z. B. die Struktur des Bauelements innerhalb des gebondeten Wafers, die Erkennung von Hohlräumen und Fehlern sowie die Live-Abbildung der mechanischen Bewegung
Im Folgenden stellen wir Beispiele für die NIR-Bildgebung zur Prüfung von elektronischen Bauteilen und Halbleitern vor. Zudem erfahren Sie mehr über Industriemikroskope, Digitalkameras und Objektive, die die NIR-Bildgebung bei diesen Anwendungen unterstützen.
Beispiele für die NIR-Bildgebung zur Prüfung von elektronischen Bauteilen und Halbleitern
Mit der NIR-Bildgebung können Prüfungen von elektronischen Bauteilen mit dem Mikroskop durchgeführt werden, die mit dem bloßen Auge nicht sichtbar sind. Im Folgenden sind einige der leistungsstarken Möglichkeiten der NIR-Bildgebung für industrielle Prüfungen angegeben:
1. Prüfung auf Beschädigungen des Chips in Wafer-Level-Chip-Scale-Package (WLCSP).
Ein Wafer-Level-Chip-Scale-Package ist ein Chip-Package integrierter Schaltungen auf Wafer-Ebene. Die NIR-Bildgebung eines Mikroskops kann zur zerstörungsfreien Prüfung auf Beschädigungen des Chips verwendet werden, die bei Hitze- und Feuchtigkeitstests auftreten. Ein IR-Mikroskop kann durch Silizium hindurch Bilder erfassen, sodass Leckstellen aufgrund von Schmelzen, Korrosion von Kupferleitungen, Ablösen von Harzteilen und andere Fehler betrachtet werden können.
2. Zerstörungsfreie Analysen von Flip-Chips.
Wie der Name schon sagt, ist ein Flip-Chip eine Chip-Package-Methode, bei der der aktive Bereich des Chips nach unten weist und direkt auf ein Substrat, eine Platine oder einen Träger montiert wird. Wenn sich der Flip-Chip auf dem Bauteil befindet, kann das Chipmuster nicht mehr mit sichtbarem Licht geprüft werden. Mit einem IR-Mikroskop kann der Prüfer durch das Silizium hindurch das Innere auf Fehler überprüfen, ohne den montierten Chip dabei zu zerstören. Dies ist auch eine effektive Methode, um die Bereiche zu identifizieren, die mit einem fokussierten Ionenstrahl (FIB) bearbeitet werden sollen.
3. Bestimmung der abgeschliffenen Menge.
Das Schleifen von Wafern ist ein Herstellungsschritt für Halbleitervorrichtungen, bei dem die Dicke des Wafers reduziert wird. Das Abschleifen der Bauteile erhöht die Notwendigkeit, beide Seiten der Wafer zu messen. Dennoch ist es äußerst schwierig, die abgeschliffene Menge auf beiden Seiten der laminierten Wafer zu messen. Ein IR-Mikroskopsystem kann Bilder durch das Material anzeigen, die auf die Vorder- und Rückseite des Wafers fokussieren, sodass der allgemeine Abstand erhalten werden kann. Dann lässt sich die abgeschliffene Menge durch Vermessen der Länge der Z-Bewegung des Objektivs bestimmen.
4. Bestimmung von Lücken in Chips anhand von 3D-Montagekonfigurationen.
IR-Mikroskope können die Bearbeitung von Siliziumlücken unterstützen. Die entstehenden Lücken in Chips können anhand einer 3D-Montagekonfiguration zerstörungsfrei bestimmt werden, indem die Länge der Bewegung des Objektivs gemessen wird, wenn IR-Licht durch das Silizium tritt und auf den Chip und den Interposer fokussiert wird. Diese Methode kann auch zur Messung und zum hohlen Aufbau von MEMS-Vorrichtungen verwendet werden.
5. Abbildung komplexer Proben.
Kurzwellen-Infrarot-Bildgebung (SWIR) bei längeren Wellenlängen, z. B. im Bereich von 1300–1500 nm, ermöglicht die Bildgebung von komplexen Proben (wie MEMS-Vorrichtungen, stark dotierten Siliziumproben, Proben mit rauer Oberfläche, Waferlöten und 3D-Chip-Stapeln. Dieses Verfahren ist mit empfindlicheren Abbildungssystemen, wie Indium-Gallium-Arsenid(InGaAs)-Kameras, möglich. Das Signal profitiert von speziellen IR-Objektiven, Hochleistungsbeleuchtung und InGaAs-Kameras, während die Auflicht- oder Durchlicht-Mikroskopie die Abbildung dieser komplexen Proben ermöglicht.
Werkzeuge für die NIR-Bildgebung: Industriemikroskope, Nahinfrarot-Kameras usw.
Verschiedene Werkzeuge sind verfügbar, um die Nahinfrarot-Bildgebung für Qualitätskontrollen und Forschungslabors (R) zu ermöglichen. Hierzu gehören:
1. Durchlicht-IR-Mikroskope
Die Auflicht-Mikroskopie eignet sich, um Proben von oben zu beleuchten. Im Vergleich dazu wird bei der Durchlicht-Infrarot-Mikroskopie die Probe von unten beleuchtet und das Licht scheint durch das Silizium, was einen höheren Kontrast ermöglicht. Die Durchlicht-Mikroskopie eignet sich zur Prüfung von Ausrichtungsmustern oder Referenzmarkierungen durch Silizium hindurch.
Unser MX63 Mikroskop bietet eine Durchlicht-IR-Betrachtung für die zerstörungsfreie Prüfung von Fehlern in IC-Chips und anderen elektronischen Bauteilen aus Silizium oder Glas, die IR-Wellenlängen problemlos durchlassen.

MX63 Prüfmikroskop für Halbleiter und Flachbildschirme
2. Nahinfrarot-Kameras
Digitale Mikroskopkameras können kontrastreiche Bilder im gesamten NIR-Spektrum bis 1100 nm liefern und gleichzeitig ein großes Sehfeld beibehalten. Unsere Monochrom-Mikroskopkamera DP23M in Kombination mit einem 1100 nm Bandpassfilter (BP) bietet eine große spektrale Empfindlichkeit von sichtbarem Licht bis zu 1100 nm. Daher eignet sich diese Kamera für die NIR-Bildgebung. Mit einer Auflösung von 6,4 Megapixel liefert die Kamera zuverlässige Graustufen- und Infrarot-Mikroskopiebilder in hoher Qualität.
Im Folgenden sind einige Beispiele gezeigt:
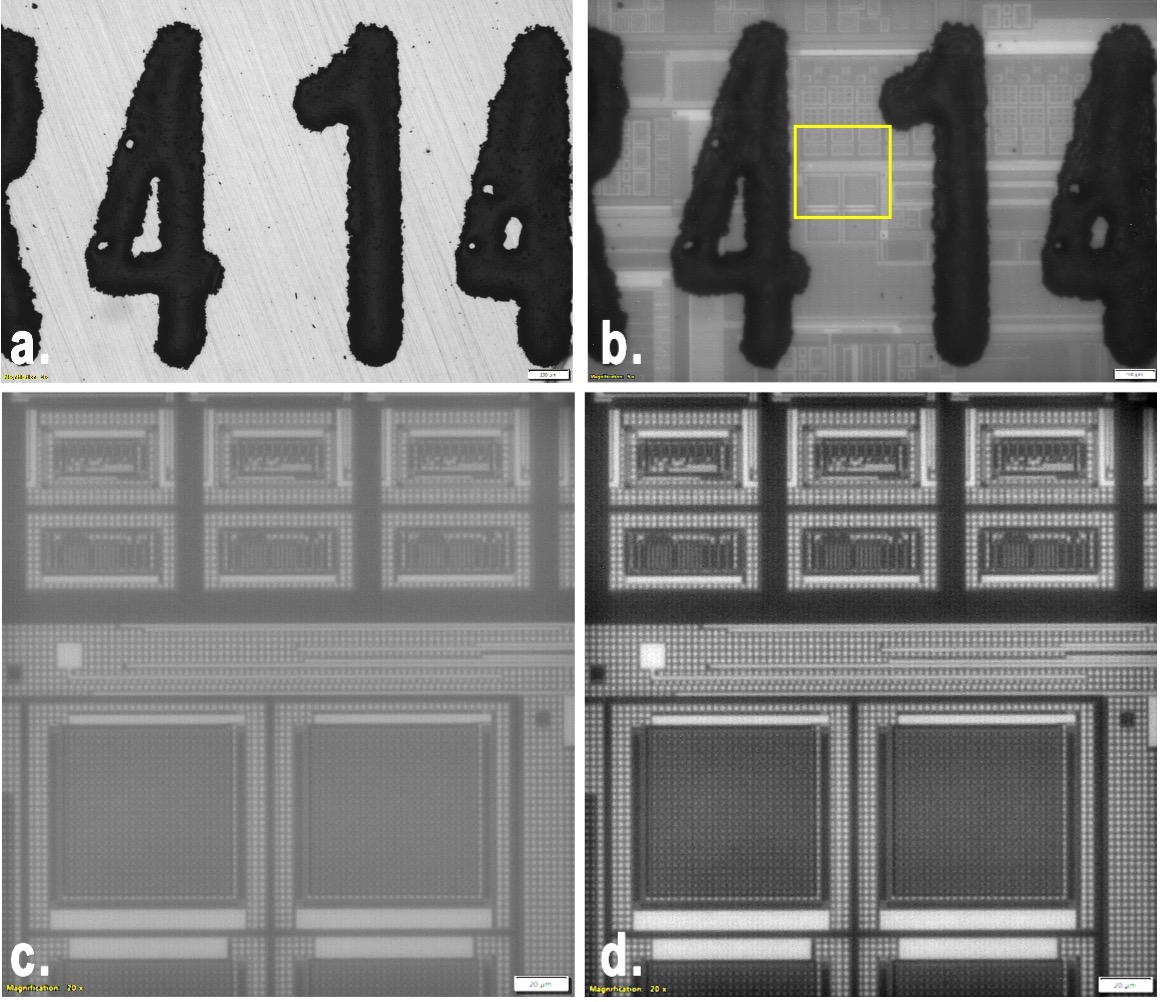
Bilder eines Halbleiterchips, aufgenommen mit der digitalen DP23M Mikroskopkamera. A) HF-Bild 5X. B) IR-Bild 5X (BP1100-nm-Filter). C) Detailausschnitt 20X IR. D) Detailausschnitt 20X IR mit einem DCE-Filter (Differential Contrast Enhancement).

Durchlicht-IR-Bild (10X) eines Halbleiterchips. Aufgenommen mit der digitalen DP23M Mikroskopkamera.

Hellfeldbild (10X) des gleichen Halbleiterchips, wie oben gezeigt. Aufgenommen mit der digitalen DP23M Mikroskopkamera.

Ein Überlagerungsbild in Falschfarben bietet einen verbesserten Kontrast auf der Probe und zeigt die helleren und dunkleren Bereiche auf dem Halbleiterchip. Hellfeld (Cyan) und Durchlicht-IR (Magenta). Aufgenommen mit der digitalen DP23M Mikroskopkamera.
3. Nahinfrarot-Objektive
Die neuesten NIR-Objektive können eine erhöhte Durchlicht-Beleuchtung im NIR-Spektrum bieten. Die Korrekturringe unserer 20X, 50X und 100X LCPLN-IR Objektive können für eine bestimmte Siliziumdicke eingestellt werden, um Durchlässigkeit, Kontrast und Aberrationskorrektur zu verbessern.

LCPLN-IR Objektive zur Prüfung innerer Strukturen in Siliziumwafern
4. Bildanalysesoftware
Die meisten Fehleranalysen und Forschungslabors verlangen einen digitalen Ansatz zur Messung von Fehlern, Berichterstellung und Archivierung von Bildern. Aufgrund dieser Anwendungsvoraussetzung (Abbildung durch das Material bei schwachem Licht) ist der zugrundeliegende Kontrast minimal und muss durch eine Bildanalysesoftware optimiert werden. Ungleichmäßige Beleuchtung, z. B. durch Vignettierung, verdunkelt die Bildecken relativ zur Bildmitte. Dies muss digital aus der Live-Ansicht und der Aufnahme entfernt werden.
Eine spezielle Software kann diese Herausforderungen lösen und bietet:
- Live-Shadingkorrektur zur Maximierung der Bildgleichförmigkeit im gesamten Sehfeld
- Genaue Messungen überall im Sehfeld
- Automatisierte Berichterstellung
- Archivierung von Bildern und relevanten Daten
Unsere IR-Mikroskope und Digitalkameras lassen sich in die PRECiV Bild- und Messsoftware integrieren, um einen nahtlosen Prüfablauf, von der Bildgebung bis zur Berichterstellung, zu ermöglichen. Kontaktieren Sie unsere Experten, um mehr über unsere Lösungen für die NIR-Bildgebung zu erfahren.
Ähnliche Themen
Industrielle DP23M Mikroskopkamera
Verwendung der PRECiV Software für die Qualitätskontrolle in der Elektronikfertigung


