반도체 제조를 위한
현미경 솔루션
- 홈
- 반도체 제조를 위한 현미경 솔루션
- 와이어 본딩
와이어 본딩
IC 칩은 와이어 본딩으로 외부 장치에 연결됩니다. 와이어 본딩은 IC 칩과 리드 프레임 사이를 용접하는 방법입니다 와이어는 하방 압력, 초음파 에너지 및 용접 열의 결합을 사용하여 리드 프레임 및 IC 칩의 알루미늄 패드에 연결됩니다.
리드 프레임의 표면 조건 분석
IC 칩과 리드 프레임의 내부 리드는 본딩 와이어로 연결되어 있습니다. 리드의 표면이 고르지 않으면 와이어 본딩의 접착 결함이 발생되므로 리드의 표면 거칠기를 측정하는 것이 중요합니다. 또 하나의 문제는 IC 패키지가 축소됨에 따라 리드가 얇아지게 되는 것입니다.
솔루션
OLS 시리즈 현미경은 거칠기 측정을 위해 초미세 리드의 이미지를 획득할 수 있습니다. 리드 프레임의 거칠기는 R 비율로 관리되며 OLS 시리즈는 필요한 매개변수를 갖추고 있습니다.
OLS 시리즈 레이저 스캐닝 현미경 | 현미경 이미지 |  표면 거칠기 |
애플리케이션 정보
관련 애플리케이션 분석:
| |||
| |||
|
매시드 볼(mashed ball)의 위치 확인
본딩 와이어의 볼 모양 끝부분에 해당하는 매시드 볼(mashed ball)은 전기 신호를 전달하도록 알루미늄 패드의 특정 위치에 놓여야 합니다. 매시드 볼이 패드의 바깥에 놓인 경우 본딩기 설정을 조정해야 합니다. 따라서 검사자는 매시드 볼 위치를 확인해야 합니다.
솔루션
고배율인 STM 시리즈 측정 현미경은 고배율로 매시드 볼 위치를 측정할 수 있습니다
STM 시리즈 측정 현미경 | 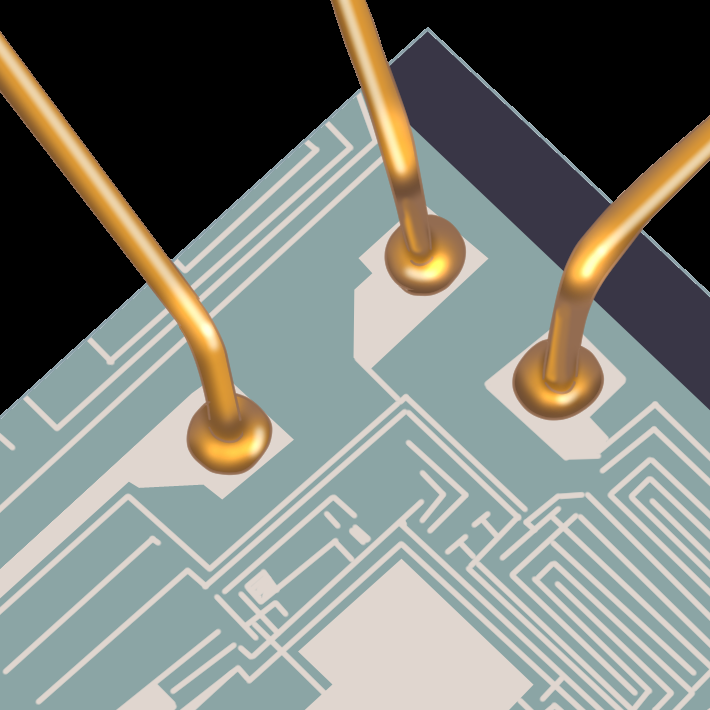 매시드 볼 | 패드의 바깥에 놓인 볼 |
애플리케이션 정보
관련 애플리케이션 분석:
| |||
| |||
 |
|
와이어 루프의 높이 측정
본딩 와이어가 IC 칩이나 패키지에 닿는 경우 단락이 발생하기 때문에 와이어 루프의 높이를 제어해야 합니다 와이어가 매우 가늘고 와이어 루프가 매우 작기 때문에 저렴한 비용으로 와이어 루프의 높이 측정을 수행하기 어렵습니다. 와이어 및 IC 칩도 비접촉 방법을 사용하여 다루어야 합니다.
솔루션
작동 거리가 길고 고배율 렌즈(50X 미만)가 장착된 STM 시리즈 측정 현미경은 루프 높이를 정확히 측정할 수 있습니다. 자동 초점 또는 초점 내비게이터 기능 같은 선택적인 품목은 측정 효율 및 정확성을 향상시킬 수 있습니다.
STM 시리즈 측정 현미경 | 본딩 와이어의 루프 높이 |
애플리케이션 정보
관련 애플리케이션 분석:
| |||
| |||
 |
|
본딩 와이어에 대한 결함 여부 확인
본딩 와이어 폭은 15–30μm 수준으로 가늡니다. 본딩 와이어의 작은 결함도 전기 신호 전달에 영향을 미칩니다. 이러한 작은 결함은 육안 검사로 발견하기 매우 어렵습니다.
솔루션
DSX1000 디지털 현미경은 본딩 와이어의 균열 및 스크래치 같은 작은 결함을 검출할 수 있습니다.
DSX 시리즈 디지털 현미경 | 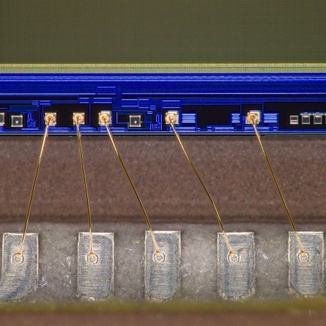 본딩 와이어(75X) | 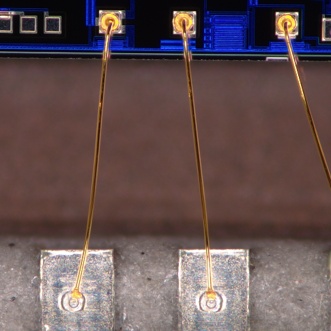 본딩 와이어(150X) |
애플리케이션 정보
관련 애플리케이션 분석:
| |||
| |||
|
알루미늄 패드의 스플래시 여부 확인
알루미늄 패드의 스플래시는 초음파 용접 중에 발생할 수 있습니다. 스플래시가 다음 패드나 볼과 패드 간 연결부에 닿는 경우 단락이 발생합니다. 이 경우 스플래시를 줄이려면 초음파 설정 변경이 필요합니다.
스캐닝 전자 현미경(SEM)은 이 검사에 일반적으로 사용되지만, 이 방법은 시간 소모가 클 수 있습니다. 간섭계를 사용하여 스플래시를 검출하는 것도 어렵습니다.
솔루션
OLS5000 레이저 컨포칼 현미경은 알루미늄 패드의 스플래시를 검출할 수 있습니다.
OLS 시리즈 레이저 스캐닝 현미경 |  |
애플리케이션 정보
관련 애플리케이션 분석:
| |||
| |||
 |
|
용접 부위의 틈 및 부식 확인
용접 부위의 틈 및 부식은 전기 신호 전달에 영향을 미치므로 틈이나 부식 여부 확인이 필요합니다. 틈이나 부식이 발견되면 용접 강도를 조정해야 합니다.
스캐닝 전자 현미경(SEM)은 이 검사에 일반적으로 사용되지만, 이 방법은 시간 소모가 클 수 있습니다.
솔루션
OLS5000 레이저 컨포칼 현미경은 9,000X 배율에서 이미지를 캡처할 수 있으며 용접 부위의 횡단면을 빠르게 관찰할 수 있게 합니다.
OLS 시리즈 레이저 스캐닝 현미경 |  용접 부위의 틈 |
애플리케이션 정보
관련 애플리케이션 분석:
| |||
| |||
|
적외선(IR) 검사
플립 칩은 후면에 전극 단자가 있는 일종의 집적 회로(IC)입니다. 플립 칩은 인쇄 회로 기판의 실장 공간을 줄여주도록 설계되어 있습니다. 플립 칩의 본딩이 부적절하거나 IC 패턴이 손상되면 고장이 야기될 수 있지만 패키징 후에는 접근이 불가능하기 때문에 검사하기 어렵습니다.
솔루션
BX 및 MX 산업용 현미경 시리즈의 IR 이미징 기능은 실리콘의 전달 속성으로 인한 패키징 후 플립 칩의 비파괴 내부 관찰을 수행할 수 있게 해줍니다. 이 검사 방법은 MEMS 웨이퍼에도 사용됩니다.
IR 장치가 장착된 BX 시리즈 금속 현미경 | IR 장치가 장착된 MX 시리즈 반도체 현미경 | 플립 칩 |
애플리케이션 정보
관련 애플리케이션 분석:
| |||
| |||
|
BX 시리즈 금속 현미경 | MX 시리즈 반도체 현미경 |
