배경
적외선(IR) 탐상을 위한 안테나 커플 나노서모커플(ACNTCs)은 IR 방사의 파장 특성을 기반으로 합니다. 입사 방사선과 길이를 맞춘 안테나가 전자기파를 수신하고 방사유도된 안테나 전류가 나노서모커플(NTC)의 열 접점을 가열합니다. (Fig. 1) 이러한 장치들의 중심에는 제베크 현상을 통해 열을 전기 신호로 변환하는 NTC가 있습니다. 노트르담 대학교 소속 Gergo P. Szakmany 박사, Gary H. Bernstein 교수, Alexei O. Orlov 교수, Wolfgang Porod 교수 등으로 구성된 연구팀이 나노와이어에서 크기 기반 제베크 계수를 활용하는 단일 금속 나노서모커플을 개발했습니다. 단일 금속 NTC는 1번의 평판과 적층 단계만을 필요로 하기 때문에 낮은 수준의 복잡함과 제조 비용을 가집니다. |  그림 1. 적외선 탐상을 위한 안테나 커플 나노서모미터 도해. 안테나는 입사 방사선을 수신하여 나노서모커플의 열 접점을 가열합니다. |
ACNTC의 개회로 전압 반응은 주변 구조 및 소재의 열 제거 효과와 반비례하기 때문에 ACNTC가 기판과 직접 접촉하는 것은 권장되지 않습니다. ACNTC를 열적으로 격리시키기 위해 노트르담 연구팀은 공기로 채워진 공동에 매달려진 ACNTC를 제조했고, 그 결과 열 격리가 적용되지 않은 장치 대비 100배 이상 높은 장치 반응을 얻었습니다. 실험 결과를 통해 열 격리가 증가할수록 공동이 적외선파를 안테나로 반사시켜 안테나가 구조적 또는 파괴적 간섭을 일으키기 때문에 ACNTC의 반응은 공동 기반이라는 것을 확인할 수 있습니다. 그래서 공동의 물리적 치수의 특성화가 장치 거동을 이해하는데 매우 중요한 역할을 수행합니다. 연구팀은 이를 위해 Olympus LEXT™ OLS5000 레이저 스캐닝 컨포칼현미경을 선택했습니다. OLS5000 현미경은 공동의 깊이와 프로필에 대한 빠르고 정확한 비파괴 계측을 수행할 수 있는 도구입니다. 이에 더해 100nm 이하의 ACNTC 구성부품 이미지 생성 시 뛰어난 해상도를 제공합니다.
Olympus 솔루션
연구팀은 노트르담의 집속 이온빔(FIB)을 사용하여 절단면을 따라 공동 단면 및 단일 프로필 계측을 수행했습니다. 이 공정은 선명한 프로필 에지를 생생하기 위해 기판 전체에 백금을 적층한 후 공동과 최소 유사한 수준의 깊이를 생성하기 위해 긴 에칭 단계를 거칩니다. 마지막으로 FIB의 스캐닝 전자 현미경 기능을 사용하여 단면의 이미지를 캡처합니다. 이러한 듀얼빔 시스템의 가격이 200만 달러 이상이기 때문에 이 공정의 가격은 매우 높으며, 시간도 많이 소요될 뿐더러 대상을 파괴해야 합니다. 이에 대한 대안으로 연구팀은 Olympus LEXT™ OLS5000 레이저 스캐닝 컨포칼현미경을 선택하여 FIB에서 생성되는 단일 선이 아닌 공동 전체의 프로필 정보(그림 2)를 캡처했습니다. OLS5000 현미경은 단면의 선을 따라 형성된 프로필만을 캡처하는 FIB와 달리 공동 전체의 프로필을 계측할 수 있습니다. OLS5000 현미경의 비파괴 특성은 연구팀이 검사 후 파괴되는 특별한 샘플을 제조하지 않고 제조 과정, 전기 및 적외선 테스트 이후 중 아무 때나 장치를 검사할 수 있게 되었습니다. 연구팀이 스타일러스 프로파일로미터와 원자간력 현미경(AFM) 대신 OLS5000을 선택한 이유는 OLS5000 현미경이 급격한 경사의 측면벽 프로필을 계측할 수 있고 깊은 공동의 바닥에도 도달할 수 있는 특징 때문이었습니다. 프로파일로미터의 스타일러스 팁은 측면벽과 부딪칠 수 있고, AFM을 사용하여 계측할 경우 깊이가 몇 마이크론 수준으로 제한됩니다. 스타일러스와 AFM 팁은 매달린 ACNTC를 손상시킬 수도 있습니다. 이에 더해 모든 대체 방식(FIB, 스타일러스 기반 프로파일로미터, AFM)은 매우 느리기 때문에 비용효과가 높지 않습니다. FIB를 사용하여 1개 공동의 깊이를 계측하는데 1.5 시간이 소요되는 반면, Olympus LEXT OLS5000 레이저 스캐닝 컨포칼현미경을 사용한 더 포괄적인 결과를 얻는데 필요한 시간은 3분 미만입니다.
 | 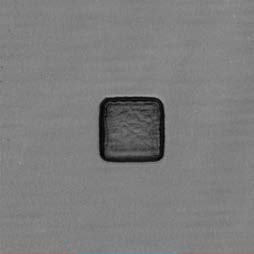 |
그림 2. (a) FIB에 의해 발생한 공동 손상의 레이저 스캐닝 이미지 (b) 손상되지 않은 공동. OLS5000 현미경은 비파괴 방식이므로 장치 공정 중 아무 때나 이미지를 캡처할 수 있습니다.
에칭 깊이 계측: 노트르담 대학에서는 전자 빔 평판, 금속 적층, 리프트오프 기술을 사용하여 실리콘(Si) 웨이퍼에 ACNTC를 제작했습니다. ACNTC가 완성되면 Si 기판의 이플루오린화 제논(XeF2) 에칭을 통해 공동을 생성합니다. 압력과 에칭 시간이 공동의 깊이와 폭을 결정합니다. 공동의 깊이는 1μm ~ 25μm 사이였습니다. (그림 3 및 4) 연구팀은 한때 원자간력 현미경(AFM)을 사용하여 공동의 깊이와 폭을 계측하려 했으나, AFM은 깊이 5 μm 수준의 공동으로 계측이 제한되었고, 이보다 깊은 공동의 바닥에는 도달하지 못했습니다. OLS5000 현미경은 AFM보다 쉽고 빠르게 공동의 깊이를 정확하게 계측(그림 3)할 수 있습니다.

그림 3. 공동 깊이 계측. OLS5000 현미경은 2개 지점 사이 공동의 깊이 정보를 빠르게 제공합니다.
공동 프로필 계측: XeF2 에칭의 등방성으로 인해 공동의 프로필은 구형의 형체를 가집니다. 이로 인해 공동은 열 격리의 역할 뿐만 아니라 적외선을 안테나로 다시 반사시켜 공동의 깊이와 방사선의 파장에 따라 구조적 또는 파괴적 간섭을 일으킵니다. 그 결과 ACNTC의 반응은 공동 깊이에 따라 진동합니다. 연구팀은 실험 결과를 뒷받침하기 위해 정량적 시뮬레이션을 사용했습니다. 간단한 가정 모델을 사용할 경우 구형의 공동을 충분하게 예상하지 못하기 때문에 공동의 정확한 시뮬레이션을 위해 공동의 프로필은 정확하게 계측되어야 합니다. OLS5000 현미경은 CAD 소프트웨어(그림 5) 시뮬레이터에 사용될 공동의 3D 프로필(그림 4)을 생성할 수 있었습니다. 3D 프로필은 2D 라인 프로필(그림 4c)와 공동의 회전 대칭 또는 공동의 3D 이미지(그림 4a, 4b)를 사용하여 생성했습니다. 그 결과, 시뮬레이션은 공동이 구조적 및 파괴적 간섭을 일으킨다는 것을 확인했습니다.
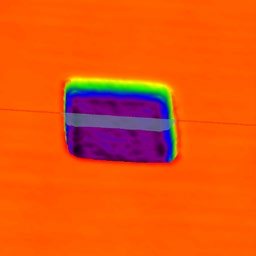 | 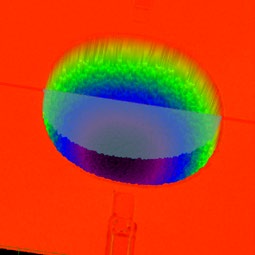 |
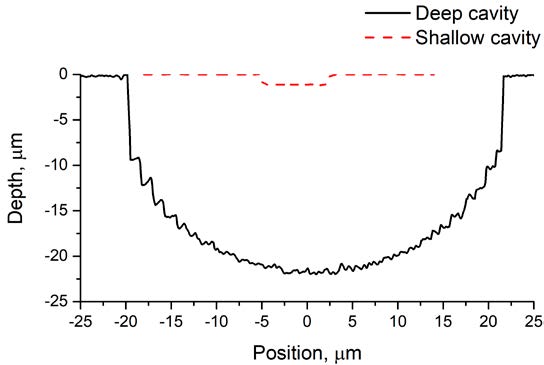
그림 4. 공동 프로필 계측. (a) 1.07 μm 깊이 공동 및 (b) 21.94 μm 깊이 공동. (c) 두 공동의 프로필. OLS5000 현미경은 얕거나 깊은 공동을 맵핑하는데 적합합니다.
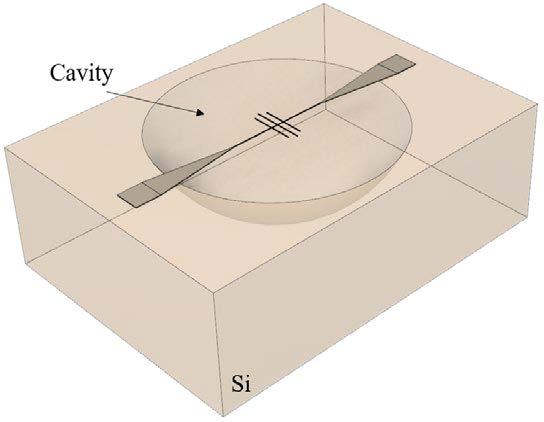
그림 5. 공동 프로필 계측을 바탕으로 생성된 공동 CAD 모댈,
ACNTC 이미지 캡처: 1차 및 2차 안테나는 몇 마이크론 수준의 길이를 가지고 있으며 공동에 완전히 매달려 있습니다. 그 결과 제작 오류에 취약합니다. 연구팀은 OLS5000 현미경을 통해 100nm 미만의 폭을 가진 ACNTC 와이어를 선명하게 관찰하여 제조 직후 장치 무결성(그림 6, 7)을 빠르게 평가할 수 있었습니다. 장치의 전류 전압(IV) 특성이 전기적 연속성을 보여주지만, 장치의 성능 저하를 야기할 수 있는 안테나의 기하학적 왜곡(그림 8)에 대한 정보는 제공하지 않습니다. OLS5000 현미경은 작업자에게 와이어 본딩 및 적외선 테스트 대상 장치를 선택할 수 있는 능력을 제공합니다. 샘플이 충전되는 것을 방지하기 위해 얇은 금속 레이어로 샘플을 코팅하기 때문에 적외선 테스트 전 스캐닝 전자 현미경을 사용하는 것은 적절하지 못합니다. 이 공정은 파괴적이기 때문에 장치를 전기적으로 단락시킬 수 있습니다. 이에 더해 SEM 스캐닝 시 부적절하게 샘플을 취급할 경우 장치의 ESD 손상이 발생할 수 있습니다. 공동의 3D 프로필 생성과 안테나의 무결성 평가를 동시에 실행하는 능력은 시간 뿐만 아니라 비용 측면에서도 매우 효율적입니다.
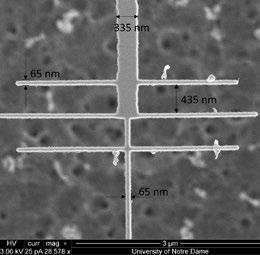 | 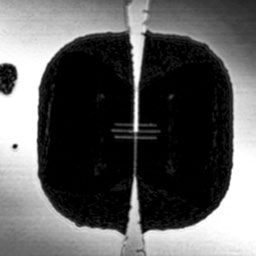 |
그림 6. a) ACNTC 스캐닝 전자 현미경 관찰. b) 같은 장치의 LEXT OLS5000 광학 현미경 관찰. 뛰어난 이미지 품질과 해상도는 제작 후 장치의 무결성을 빠르게 검사할 수 있습니다. 수평선을 기준으로 중심 간격 거리가 500 nm 미만이며 폭은 65 nm입니다.

그림 7. 1차 및 2차 안테나의 3D 이미지.
 | 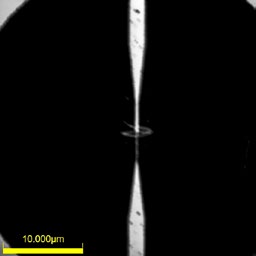 |
그림 8. 장치 무결성 검사. (a) 전기적 연속성을 가진 장치의 SEM, b) 유사 장치의 OLS5000 현미경 이미지. 레이저 스캐닝 이미지에서 제작 시 안테나가 손상되었다는 것을 확인할 수 있습니다.
OLS5000에는 긴 작동 거리를 가진 렌즈가 장착되어 뛰어난 이미지 품질을 제공합니다. (그림 9) 이 옵션을 통해 작업자가 칩 캐리어 안의 ACNTC 와이어 본딩을 제거하지 않고 이미지를 캡처할 수 있게 해줍니다.
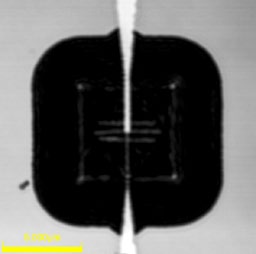
그림 9. OLS5000 현미경 긴 작동 거리 렌즈(LMPLFLN100xLEXT)를 사용하여 캡처한 ACNTC 와이어 본딩의 레이저 스캐닝 이미지. 긴 작동 거리를 통해 샘플 제거 및 파괴 없이 칩 캐리어 안의 장치 이미지를 생성할 수 있습니다.
요약 및 결론
노트르담 대학 연구팀이 Olympus LEXT™ OLS5000 레이저 스캐닝 컨포칼현미경을 사용하여 공기로 채워진 공동에 매달린 ACNTC의 기하학적 특성을 캡처했습니다. OLS5000 현미경은 공동의 3D 이미지와 프로필을 제공합니다. 해당 데이터는 장치 예측과 실험 결과를 뒷받침하는데 사용되었습니다. 우수한 이미지 품질은 안테나 구조 제작 후 100nm 미만의 부품에 대한 중요한 장치 무결성 정보를 제공했습니다. ACNTC와 공동의 물리적 치수가 비파괴 방식으로 정확하게 계측되었고, 그 과정에 소요된 시간과 비용은 FIB, SEM, 프로파일로미터, AFM 등의 타 측정 방식 대비 크게 감소했습니다.
이 작업은 노트르담 나노 과학기술 센터의 지원을 받아 노트르담 통합 이미징 시설 및 노트르담 나노제작 시설에서 진행되었습니다.
저자 소개
Gergo P. Szakmany 박사, Alexei O. Orlov 교수, Prof. Wolfgang Porod 교수, Gary H. Bernstein 교수는 노트르담 대학 전기공학 부서 소속으로 활동하고 있습니다.
G. P. Szakmany의 작업은 노트르담 Joseph F. 트러스티 박사과정 펀드의 지원을 받았습니다.

