背景
赤外線(IR)検出用のアンテナ結合ナノ熱電対(ACNTC)は、IR放射の波動性に基づいています。入射する赤外線放射にマッチした長さのアンテナが電磁波を受信し、放射で誘導されるアンテナ電流がナノ熱電対(NTC)の熱接点を加熱します(図1)。これらのデバイスの心臓部となるのが、ゼーベック効果によって熱を電気信号に変換するNTCです。最近、Gergo P. Szakmany博士、Gary H. Bernstein教授、PAlexei O. Orlov教授およびWolfgang Porod教授をはじめとするノートルダム大学の研究グループが、ナノワイヤーにおけるサイズ依存性のゼーベック係数を利用する、単一金属ナノ熱電対を発明しました。単一金属NTCは、1つのリソグラフィおよび堆積ステップのみを必要とするので、複雑さが少なく、製造コストも低くなります。 | 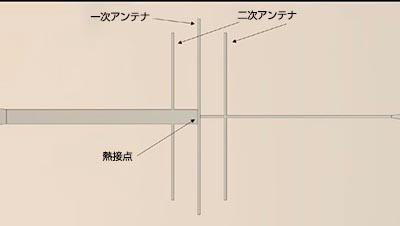 図1IR検出用アンテナ結合ナノ熱電対の概略図。アンテナが入射する赤外線放射を受信して、ナノ熱電対の熱接点を加熱します。 |
ACNTCの開回路電圧レスポンスは隣接構造と材料の熱除去作用に反比例するので、ACNTCが材料と直接接触することは望ましくありません。ACNTCを熱的に絶縁するために、ノートルダムのチームが空気が満たされた空洞中に懸架したACNTCを作成したところ、熱絶縁のないデバイスに比べて応答が約100倍増加しました。実験結果から、空洞は、熱絶縁に加えて、IR波を反射してアンテナに戻すことにより建設的干渉または相殺的干渉のいずれかが生じるため、ACNTCの反応は空洞の深さに依存することが分かりました。したがって、装置の動作を理解するには空洞の物理寸法のキャラクタリゼーションが重要な意味を持ちます。ノートルダムのチームはこの目的のために、オリンパスLEXT OLS5000レーザー顕微鏡を選択しました。OLS5000顕微鏡は、空洞の深さとプロファイルを、迅速、正確、非破壊的に測定する優れたツールです。さらに、ACNTCの100 nm未満の構成部品をイメージングするための、優れた解像度も備えています。
オリンパスのソリューション
ノートルダムのチームは長い間、空洞の横断図の作成と、切断線を横断する単一プロファイルの測定をノートルダムの集束イオンビーム(FIB)装置に依存していました。このプロセスには、鋭利なプロファイル端部を作成するために基板全体にプラチナを付着させ、その後少なくとも空洞の深さまでエッチングするという、長時間にわたるステップが必要です。最終的に、FIBの走査型電子顕微鏡機能を使って横断面がイメージングされます。このようなデュアルビームシステムには少なくとも200万ドルがかかるため、このプロセスは高価であり、また時間がかかり、破壊的でもあります。これに代わる方法として、FIBの場合における単一ラインだけではなく、空洞全体のプロファイル情報を提供するために(図2)、ノートルダムのグループはオリンパスLEXT OLS5000レーザー顕微鏡を選択しました。FIBは単に横断面線に沿ってプロファイルを実行するだけですが、OLS5000は空洞の内部全体のプロファイルを測定します。他の方法だとサンプルを破壊しなければなりませんが、OLS5000は非破壊的な性質のため特別なサンプル調整を一切必要としないので、チームはデバイスを製造するどのステップでも、さらに電気的試験とIR試験の後にも検査することができるようになりました。さらにチームは、OLS5000が急勾配の側壁プロファイルを測定可能であり、深い空洞の底まで到達可能であることを理由に、スタイラスベースのプロフィルメーターおよび原子間力顕微鏡(AFM)に代えてOLS5000を選択しました。プロフィルメーターのスタイラスチップは側壁と衝突することがあり、またAFMで測定する場合は深さが数ミクロンに制限されてしまいます。スタイラスとAFM先端は、懸架されたACNTCを傷めることもあります。さらに、これらの代替法(FIB、スタイラスベースのプロフィルメーター、およびAFM)は全て測定速度が非常に遅いため、費用対効果の点でも劣っています。FIBで単一の空洞の深さを測定するために約1.5時間かかるのに対し、オリンパスLEXT OLS5000レーザー顕微鏡では3分未満でより総合的な結果が得られます。
 | 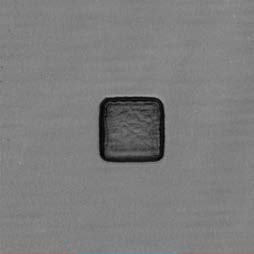 |
図2 (a)レーザー走査画像はFIBによる損傷を受けた空洞を示す。(b)損傷を受けていない空洞。OLS5000は非破壊的であるため、デバイスのプロセスフロー中のどのポイントでも空洞をイメージングすることができます。
エッチングの深さ測定:ノートルダム大学では、ACNTCは、電子ビームリソグラフィ、金属付着、および剥離技術を使用してシリコン(Si)ウェハー上に製造されます。ACNTCが製造された後、Si基板の二フッ化キセノン(XeF2)エッチングによって空洞が形成されます。圧力とエッチング時間が空洞の深さと幅を決定します。空洞の深さの範囲は1 μm~25 μmです(図3および4)。あるとき、研究者たちは空洞の深さと幅を測定するために原子間力顕微鏡(AFM)を使ってみましたが、AFMでは深さ5 μmの空洞が限界で、それ以上深い空洞では底まで到達できませんでした。OLS5000を使うと、空洞(図3)の深さをAFMよりも正確に、より容易に、非常に速く測定できました。

図3 空洞の深さの測定。OLS5000は、空洞の深さを2点間の距離で迅速に提供
空洞プロファイルの測定:XeF2エッチングは等方性の性質を持つため、空洞のプロファイルは球形になります。そのため、空洞は熱絶縁として機能するだけでなく、IR波を反射してアンテナに戻すため、空洞の深さと放射される波長に依存して建設的干渉または相殺的干渉のいずれかが生じます。その結果、ACNTCの反応は空洞の深さによって変動します。研究者たちは、実験結果を裏付けるために数値シミュレーションを使用しました。空洞を球形としてモデル化する単純な仮説では正確さの点で不十分であるため、正確なシミュレーションのためには空洞のプロファイルを精密に測定しなければなりません。OLS5000を使用することで、CADソフトウェア(図5)を使用するシミュレータのための、空洞の3Dプロファイル(図4)の作成が可能になりました。3Dプロファイルは、2D線形プロファイル(図4c)と空洞の回転対称を利用することにより、または空洞の3D画像をCAD(図4aおよび4b)にエクスポートすることにより作成されました。その結果シミュレーションは、空洞により建設的干渉と相殺的干渉が生じているという仮説を証明しました。
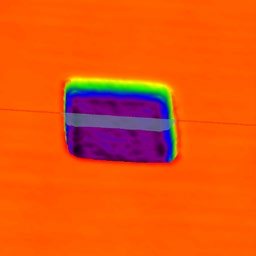 | 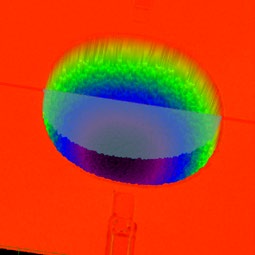 |
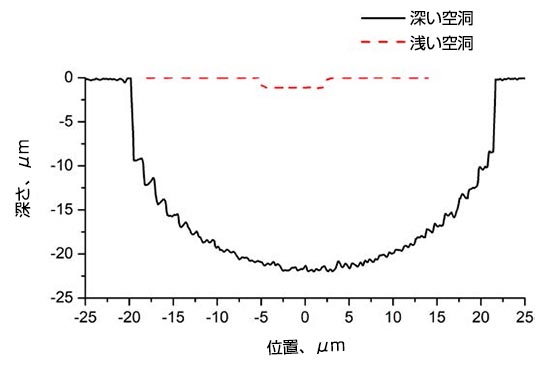
図4空洞プロファイルの測定値。(a)深さ1.07 μmの空洞、および(b)深さ21.94 μmの空洞。(c)2つの空洞のプロファイル。OLS5000は、浅い空洞と深い空洞をマップするための優れたツールであることが証明されました。
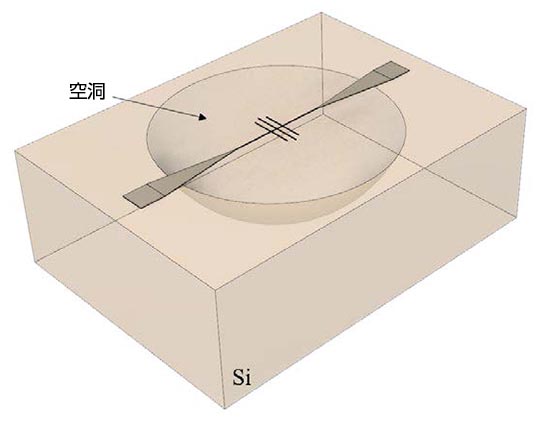
図5 空洞プロファイル測定値に基づいて構築された空洞のCADモデル
ACNTCのイメージング:1次アンテナと2次アンテナの長さは数ミクロンで、空洞の上に完全に懸架されています。結果的に、これらのアンテナは製造時のエラーの影響を受けやすくなっています。チームは、OLS5000がACNTCの幅100 nm未満のワイヤを解像でき、製造直後にデバイスの完全性の迅速な測定(図6および7)を実現できることを発見しました。デバイスの電流電圧(IV)キャラクタリゼーションでは電気的導通が示されますが、これは、デバイスの性能を損ない得るアンテナの幾何学的歪み(図8)に関しては、いかなる情報も提供しません。OLS5000を使用することで、研究者はワイヤボンディングおよびIR試験に用いるデバイスを選択できるようになります。走査型電子顕微鏡法は、帯電を防ぐためにサンプルを薄い金属層でコートしなければならないため、IR試験前に使用するには不適切です。このようなプロセスは、デバイスを電気的にショートさせるという点で破壊的です。加えて、SEM操作中のサンプルの不適切な取扱いがデバイスをESD破壊することもあり得ます。空洞の3Dプロファイリングとアンテナの完全性の評価を同時に行えることは、時間とコストの両面で効率的だと言えます。
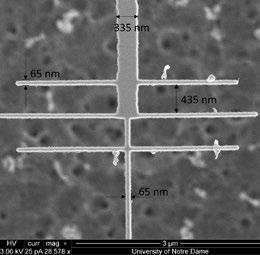 | 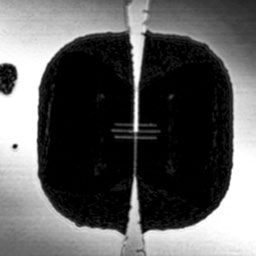 |
図6 a)ACNTCの走査型電子顕微鏡写真。b)同じデバイスのLEXT OLS5000レーザー顕微鏡写真。優れた画質と解像度が、製造後のデバイスの完全性の迅速な検査を可能にする。水平ラインのセンター間距離は500 nm、幅は約65 nmである。

図7 1次および2次アンテナの3D画像
 | 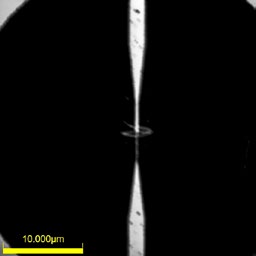 |
図8 デバイスの完全性の検査。(a)電気的導通デバイスのSEM、および(b)同様のデバイスのOLS5000の画像。レーザー走査画像は、アンテナが製造中に損傷を受けたことを示しています。
OLS5000は、優れた画質を提供する長作動距離WDレンズを備えています(図9)。このオプションを使用すると、研究者はチップキャリアに搭載されたワイヤボンディング済みのACNTCを、取り外さずにイメージングできるようになります。
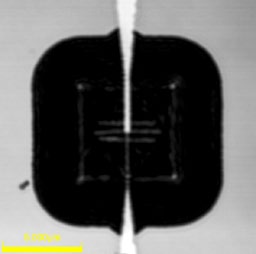
図9 OLS5000の長作動距離レンズ(LMPLFLN100xLEXT)でイメージングした、ワイヤボンディング済みACNTCのレーザー走査画像。長い作動距離を用いることで、サンプルを取り出して破壊することなく、チップキャリア中のデバイスをイメージングすることが可能になります。
要約と結論
ノートルダム大学のグループは、オリンパスLEXT OLS5000レーザー顕微鏡を使用して、空気が満たされた空洞に懸架ACNTCのジオメトリをキャラクタライズしました。OLS5000は、空洞の3D画像とプロファイルを提供しました。デバイスのモデル化および実験結果を裏付けるための数値シミュレーションに、これらのデータが使用されました。優れた画質により、アンテナ構造の100 nm未満の部分に関する、非常に貴重なデバイスの製造後の完全性情報が得られました。ACNTCおよび空洞の物理的寸法が、FIB、SEM、プロフィルメーター、およびAFMなどのその他の測定方法と比べてはるかに少ない時間とコストで、正確に、非破壊的に収集されました。この研究は、Notre Dame Center for Nano Science and Technologyの支援を受けて、Notre Dame Integrated Imaging FacilityおよびNotre Dame Nanofabrication Facilityで行われました。
著者について
Gergo P. Szakmany博士、Alexei O. Orlov博士、Wolfgang Porod博士、およびGary H. Bernstein博士は、Department of Electrical Engineering University of Notre Dameに所属している。G. P. Szakmany博士の研究は、Notre Dame Joseph F. Trustey Fund for Postdoctoral Scholarsの資金援助を受けて行われました。

